出於(yu) 製造成本考慮,製造商需要生產(chan) 功能更強大、但更小和更節能的設備,因此,激光技術在半導體(ti) 以及微電子製造過程中的作用正在急劇增強。與(yu) 現有的智能手機相比,下一代產(chan) 品需要具備更強大的處理能力和高質量顯示屏,而且這種趨勢日益顯著。零部件製造商已經逐漸轉向具備高分辨率、高能量以及低損傷(shang) 加工特性的紫外(UV)和深紫外(DUV)激光器來實現智能手機的生產(chan) 。
本文闡釋了激光器應用於(yu) 智能手機製造的實例,並對因應未來需求而研發的新激光技術進行了綜述。
晶片切割
智能手機所需的小物理尺寸與(yu) 高性能需要較薄的內(nei) 存晶片(用於(yu) 先進的封裝)以及組成低電介質的晶片,以改進功耗。這兩(liang) 種晶片對傳(chuan) 統模具切割(采用鋸)方式提出了挑戰。特別是,低電介質具備高多孔性、柔軟性以及低粘附性,令傳(chuan) 統的鋸切割難以應對。目前, “半切割”的激光劃片已經成為(wei) 用於(yu) 切割低電介質最普遍的方法。
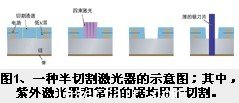
在這一過程中,激光器被用於(yu) 切穿軟質外延層,從(cong) 而使軟質外延層在模具上絕緣,並使其邊緣層相對清潔,沒有損壞。隨後矽片將被機械鋸切而無須擔心外延層與(yu) 鋸片接觸。
對內(nei) 存晶片而言,機械鋸切在工業(ye) 中仍然居於(yu) 主導地位;但是隨著晶片變薄,機械鋸切會(hui) 產(chan) 生裂縫或斷裂,由此必須較慢地進行,因而降低了產(chan) 能。我們(men) 可以利用激光完全切穿晶片,以避免這些問題。對於(yu) 100 m以下的晶片厚度,可以預期激光切割與(yu) 鋸切之間的總成本相仿;對50 m以及更小晶片所做的激光加工,它將更具優(you) 勢。
當前,類似Coherent公司AVIA係列355-23-250這樣的半導體(ti) 泵浦固體(ti) 激光器,已經針對晶片劃片做了特殊的設計和優(you) 化,並且成為(wei) 切割應用的首選設備。短波長帶來小的熱影響區域(HAZ),並且調Q激光器的短脈寬(數十納秒)意味著每個(ge) 脈衝(chong) 的熱能被減小到最低限度,並且可以在下一個(ge) 脈衝(chong) 到達之前通過傳(chuan) 導而消散。高重複頻率以及高功率降低了總擁有成本(COO),從(cong) 而促使製造成本下降。
未來趨勢:采用更高精度切割可以帶來加工簡單化以及精度方麵的益處。近來出現的工業(ye) 用皮秒激光器成為(wei) 了一種有效的解決(jue) 方法。皮秒脈衝(chong) 主要通過稱為(wei) 多光子吸收的光學過程去除材料。這是一個(ge) 相對冷(非熱)的過程,可以帶來比納秒激光器更優(you) 異的邊緣質量,從(cong) 而提高成品率,並且有可能無須進行後續加工。Coherent公司的Talisker係列激光器在355 nm波長下提供了4 W的輸出,脈衝(chong) 寬度為(wei) 15 ps,這種全新的工業(ye) 皮秒激光器已經通過實踐證明了其提供前所未有的超高精度、速度以及可靠性的能力。

激光直接成像
智能手機中,將更多電路安裝到更小空間的需求導致了越來越多地使用高密度互連(HDI)電路板,而激光直接成像(LDI)在生產(chan) 這種電路板方麵已成為(wei) 一項關(guan) 鍵的技術。在LDI中,鎖模的紫外激光器可將圖案直接成像到塗有光刻膠的麵板上,完全排除了使用傳(chuan) 統的成像工具(即膠片)。LDI最明顯的好處是節省了與(yu) 這些成像工具的生產(chan) 、使用、處理以及存儲(chu) 有關(guan) 的時間和成本。LDI還提供了明顯優(you) 於(yu) 傳(chuan) 統的接觸印刷製備方法的精度。
Coherent公司的Paladin係列激光器是專(zhuan) 門為(wei) 滿足LDI以及其他需要可靠、高功率紫外激光光源的應用而開發的。Paladin係列是鎖模的半導體(ti) 泵浦三倍頻固體(ti) 激光器,波長355 nm,輸出功率可以高達16 W。Paladin係列的全固態構造堅固耐用、具有高可靠性和長壽命,並且具備卓越的模式質量和極好的指向穩定性、功率穩定性以及噪聲特性。16 W的輸出功率可以在保持足夠的加工產(chan) 能的同時,使用較廉價(jia) 的幹膜。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

