近二十年來,GaN 基半導體(ti) 材料在外延生長和光電子器件製備方麵均取得了重大科技突破,其中發光二極管(LED)和邊發射激光器(EEL)已經實現產(chan) 業(ye) 化,但是具有更優(you) 越特性的垂直腔麵發射激光器(VCSEL)仍處於(yu) 實驗室研究階段。VCSEL 的獨特優(you) 點包括閾值電流低、易實現單縱模工作、調製頻率高、發散角度小、圓形光斑、易與(yu) 光纖耦合、不必解理即可完成工藝製作和檢測,易實現高密度二維陣列及光電集成等。藍綠光 VCSEL 憑借以上優(you) 勢,在高密度光存儲(chu) 、激光顯示、激光打印、激光照明、激光電視、水下通信、海洋資源探測及激光生物醫學等領域具有廣闊的應用前景。
然而由於(yu) VCSEL 諧振腔短(僅(jin) 幾微米長),導致其單程增益長度也極短,因此就要求製作的分布布拉格反射鏡(DBR)材料質量必須良好,還要求 DBR 的反射率極高(通常要求達到 99%以上)。與(yu) GaN 基邊發射激光器(EEL)或者 GaAs 基垂直腔麵發射激光器(VCSEL)相比,GaN 基 VCSEL 的研究開發進展仍相對緩慢,其主要原因是外延生長高質量的氮化物異質結(AlN/GaNAlGaN/GaN 或 AlInN/GaN) DBR 非常困難。研發 GaN 基 VCSEL 已經成為(wei) 國內(nei) 外光電子領域研究的前沿和熱點[1]-[9],國內(nei) 外許多研發機構都投入了大量的人力和物力進行基礎研究和應用開發,爭(zheng) 取早日實現實用化。我國在 GaN 基電注入藍綠光VCSEL 研究方麵起步較晚,與(yu) 國際先進水平差距較大。
2. 藍綠光垂直腔麵發射激光器國內(nei) 外研究現狀
垂直腔麵發射激光器(Vertical Cavity Surface Emitting Laser,簡稱VCSEL),其諧振腔是由在有源區(Active Region)的上下兩(liang) 邊形成兩(liang) 個(ge) 具有高反射率的分布布拉格反射鏡(Distributed Bragg Reflector,簡稱DBR)構成,激光沿著材料外延生長方向垂直出射。邊發射激光器(Edge Emitting Laser,簡稱 EEL)和垂直腔麵發射激光器(VCSEL)結構示意圖如圖 1 所示。由於(yu) 外延生長高質量的氮化物異質結 DBR 非常困難,因此如何獲得高質量的氮化物 DBR 成為(wei) VCSEL 研究中最主要的難點。
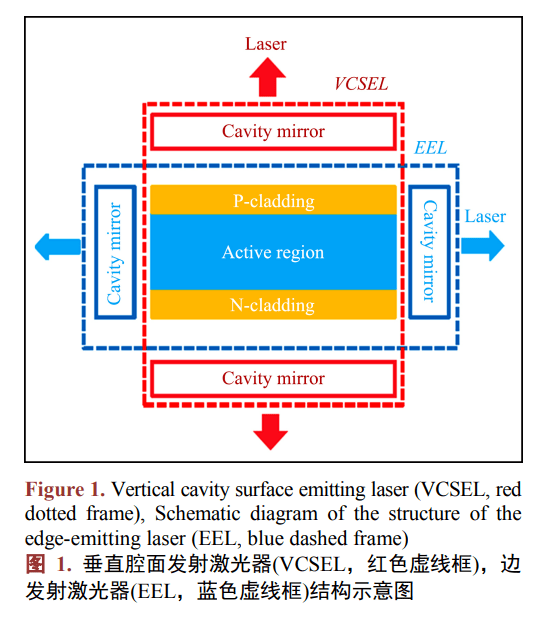
為(wei) 了降低外延生長氮化物異質結雙 DBR 的難度,研究人員報道了一些混合式 DBR 結構 VCSEL 的解決(jue) 方案。例如,采用氮化物異質結底部 DBR (Epitaxial DBR)和介質膜頂部 DBR (Dielectric DBR)組成的一種混合式 DBR 結構 VCSEL,如圖 2(a)所示,在襯底上外延生長底部氮化物異質結 DBR 與(yu) 發光層,再鍍膜沉積頂部介質膜 DBR。由於(yu) 介質膜 DBR 不受晶格匹配的限製,可以自由選用折射率差值大的兩(liang) 種介質材料,因此更易於(yu) 獲得高反射率和高反射帶寬。1999 年《Science》雜誌[1]報道了日本東(dong) 京大學的Arakawa 研究組利用外延生長的 AlGaN/GaN 底部氮化物 DBR 和 ZrO2/SiO2 頂部介質膜 DBR 組成的混合式 DBR 結構 VCSEL,率先實現了室溫光注入脈衝(chong) 激射。2010 年台灣交通大學的 Hao-Chung Kuo 研究組[2]製備了 AlN/GaN DBR 和 Ta2O5/SiO2 介質膜 DBR 的混合式 DBR 結構 VCSEL,實現了室溫連續電注入激射,閾值電流密度為(wei) 12.4 KA/cm2;該研究組 2015 年實現了 VCSEL 的閾值電流密度為(wei) 10.6 KA/cm2,輸出功率達到 0.9 mW [3]。2012 年瑞士洛桑凝聚態物理研究所 Cosendey 等人[4]研製了 GaN 襯底上外延生長晶格匹配的 AlInN/GaN 底部 DBR 和 TiO2/SiO2 介質膜頂部 DBR 的混合式 DBR 結構 VCSEL,實現了室溫脈衝(chong) 電注入激射。以上報道的混合式 DBR 結構 VCSEL 的確能降低外延生長氮化物異質結雙 DBR的難度,但是外延生長高質量的 AlGaN/GaN 底部氮化物 DBR 的難度依然很大。
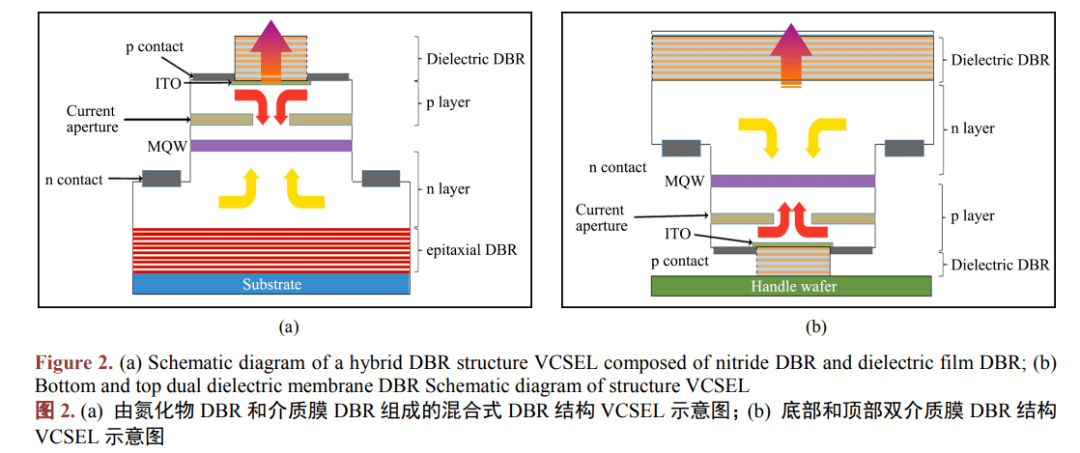
與(yu) 此同時,為(wei) 了降低外延生長氮化物異質結雙 DBR 的難度,一些研究者提出了雙介質膜 DBR 結構VCSEL 解決(jue) 方案。一些研究者提出了雙介質膜 DBR 結構 VCSEL 解決(jue) 方案。雙介質膜結構 DBR (DielectricDBR) VCSEL,如圖 2(b)所示,即通過薄膜轉移的方式去除原始襯底,製備出由底部和頂部兩(liang) 部分介質膜 DBR 構成的 VCSEL。日本鬆下公司[5]和廈門大學張保平研究組[6]均實現了 ZrO2/SiO2 雙介質膜 DBR結構 VCSEL 室溫連續電注入激射,後者閾值電流密度降低至 1.2 KA/cm2。美國加州大學聖巴巴拉分校的Nakamura 研究組[7]采用厚度小於(yu) 50 nm 的 ITO 膜內(nei) 腔電極,Ta2O5/SiO2 雙介質膜 DBR 結構 VCSEL 閾值電流密度達到 8 KA/cm2;當該研究組進一步采用隧道結代替吸收係數較大的 ITO 膜內(nei) 腔電極時,閾值電流密度下降至 3.5 KA/cm2。2016 年日本索尼公司[8]報道了 Ta2O5/SiO2 和 SiN/SiO2 雙介質膜 DBR 結構VCSEL,器件的發光波長為(wei) 453.9 nm,閾值電流密度為(wei) 22 KA/cm2,室溫連續輸出功率最高達到了 1.1 mW。2018 年索尼公司[9]報道了介質膜 Ta2O5/SiO2 雙 DBR 結構 VCSEL,並利用單微曲麵鏡對藍綠光 VCSEL側(ce) 向光場進行了限製,雖然獲得了較好的光束質量,但是閾值電流密度卻上升至 141 KA/cm2。以上研究結果表明,利用雙介質膜 DBR 結構 VCSEL 解決(jue) 方案,的確能有效降低氮化物異質結雙 DBR 材料的製作難度。然而由於(yu) 雙介質膜 DBR 不導電,因此目前電泵浦 VCSEL 均采用內(nei) 腔接觸 ITO 膜電極結構,而ITO 膜內(nei) 腔接觸電極會(hui) 產(chan) 生較高的吸收損耗,大幅度增加器件的內(nei) 部損耗,導致 VCSEL 閾值電流密度明顯升高。
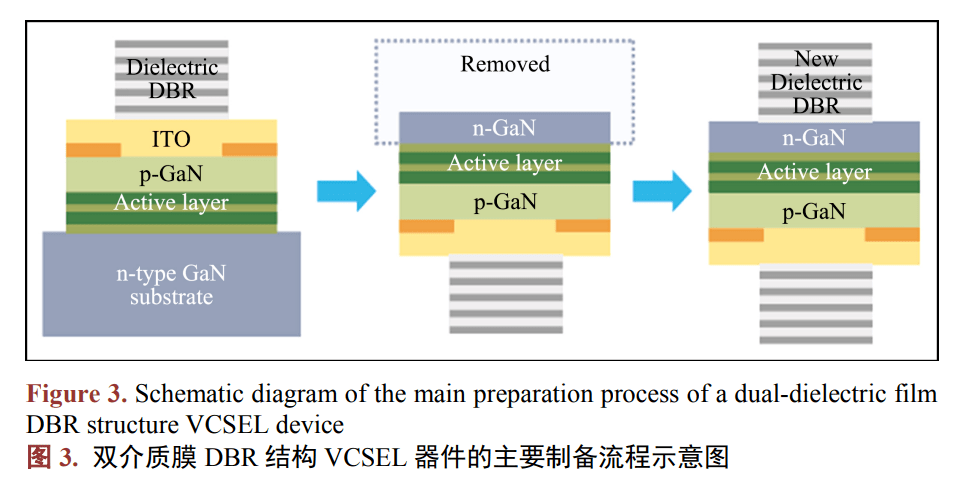
國內(nei) 外的研究結果表明,若要獲得外延生長高質量氮化物異質結 DBR,實現 GaN 基 VCSEL 室溫下電注入激射,需要解決(jue) 以下兩(liang) 個(ge) 主要難題:首先需要解決(jue) 高質量氮化物諧振腔的製作難題。高質量氮化物諧振腔難以製作的主要原因是:當采用外延生長氮化物異質結 DBR 時,高 A1 組分的 A1 (Ga) N 與(yu) GaN之間存在較大的晶格失配和熱失配,異質結外延生長過程中由於(yu) 應力積累、熱失配而產(chan) 生晶格缺陷和開裂現象,這些都加大了外延生長高質量氮化物異質結 DBR 的難度,並導致 DBR 反射率降低[1] [2] [3]。GaN 和 AlN 的晶格失配為(wei) 2.4%,折射率差約為(wei) 0.4,外延生長過程中會(hui) 產(chan) 生位錯和開裂現象,即使外延生長 Al0.5Ga0.5N/GaN (折射率差約為(wei) 0.2)異質結構,也難以獲得高質量的氮化物異質結 DBR。而采用與(yu) GaN 晶格匹配的 AlInN 材料時,其中的 In 組分又極難控製,很難獲得高質量的 AlInN/GaN 氮化物異質結 DBR,並且其較小的折射率差也使得其高反射帶寬相對較窄[4]。盡管雙介質膜 DBR 容易獲得較高的反射率,但是 VCSEL 器件的製備過程相對複雜[5] [6] [7] [8] [9],主要製備流程如圖 3 所示,首先在襯底上製作底部介質 DBR;其次通過薄膜轉移的方式去除原始襯底;最後製作頂部介質 DBR,從(cong) 而實現由底部和頂部介質膜 DBR 構成的雙介質膜 VCSEL。其次需要解決(jue) p 型 DBR 導電性差的難題。p 型 DBR 導電性差的主要原因是 AlGaN/GaN DBR 為(wei) 高阻特性,同時外延生長高 Al 組分 AlGaN 十分困難。由於(yu) 目前所采用的 p 型氮化物異質結 DBR 材料導電性較差,因而電注入 VCSEL 需要采用內(nei) 腔接觸 ITO 膜電極結構。盡管減小 ITO 膜電極厚度有利於(yu) 降低光吸收,但是 ITO 膜過薄(小於(yu) 50 nm)又會(hui) 明顯加大 ITO 膜的工藝製作難度,明顯增大器件的閾值電流密度。
3. 藍綠光垂直腔麵發射激光器國內(nei) 外研究進展
國內(nei) 外研究學者利用電化學刻蝕技術,把較高摻雜濃度的 n 型氮化镓(n+-GaN)樣品作為(wei) 陽極,浸泡在酸性[10]-[16]或堿性[17] [18]電解質中,在一定電壓的作用下,n+-GaN 會(hui) 發生電化學刻蝕反應形成納米多孔氮化镓(nanoporous GaN,簡寫(xie) NP-GaN)結構。2015 年耶魯大學 Jung Han 研究組[13]報道了不同摻雜濃度的 n 型 GaN (n-GaN/n+-GaN) DBR 樣品中的 n+-GaN 在電化學刻蝕工藝過程中形成不同孔徑尺寸的納米多孔 GaN 結構的變化規律,如圖 4(a)所示。由於(yu) 該 GaN/NP-GaN 結構 DBR 具有折射率差值較大(Δn ≥0.5)的優(you) 勢,因此使用較少對數的 DBR 就能夠獲得高反射率(R > 99%),並且高反射帶寬在紅光–藍綠光範圍內(nei) 可調,如圖 4(b)所示。2015 年韓國全南大學[14]首次實現了 GaN/NP-GaN DBR 結構 VCSEL 光注入激射發光。2017 年耶魯大學 Jung Han 研究組[19]報道了 GaN/NP-GaN DBR 結構藍紫光 LED,2018 年該組又報道了一種具有納米多孔氮化镓(NP-GaN)的 InGaN/GaN 微盤激光器[20]。這些研究結果表明了GaN/NP-GaN 構成的 DBR 具有高反射率和良好的可控性,這都為(wei) 製作高質量氮化物 VCSEL 諧振腔奠定了堅實基礎。不同的電化學刻蝕反應條件下形成不同孔徑的納米空氣孔 GaN 結構[21] [22] [23] [24] [25]。這些研究結果充分表明了 GaN/NP-GaN 構成的 DBR 具有高反射率和良好的可控性,能夠用來製作高質量氮化物 VCSEL 諧振腔。這種具有較低折射率的納米空氣孔 GaN 材料仍然具備導電的特性,表明了這種 GaN/NP-GaN DBR 結構完全可以應用在電泵浦 GaN 基 VCSEL 中。
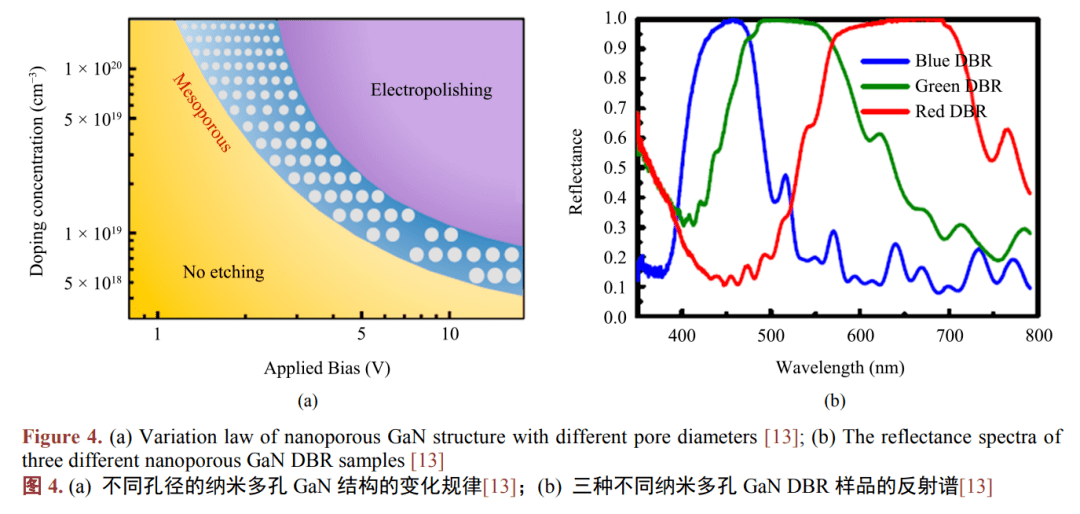
最令人關(guan) 注的是這種低折射率納米多孔 GaN 材料仍然導電的特點,表明了 GaN/NP-GaN DBR 結構可以應用在電注入 GaN 基 VCSEL 中。2013 年中國科學院蘇州納米技術與(yu) 納米仿生研究所和台灣國立彰化師範大學[26] [27]報道了隧道結 GaN 基邊發射激光器(EEL)的輸出特性的模擬研究,結果表明該結構能獲得較低的閾值電流密度和串聯電阻率,並能提高器件的輸出功率。2015 年日本和美國的研究機構[28][29] [30]報道了隧道結 GaN LED 器件的 I-V 特性得到了明顯改善。美國加州大學聖巴巴拉分校的Nakamura 研究組基於(yu) ITO 膜內(nei) 腔電極和 Ta2O5/SiO2 雙介質膜 DBR 結構,研究了離子注入孔徑(Ion Implanted Aperture)的電流注入孔徑結構VCSEL [31],結構示意圖如圖5(a)所示,閾值電流密度為(wei) 16 KA/cm2;以及空氣隙孔徑(Air-gap aperture)電流注入孔徑結構的 VCSEL [32],結構示意圖如圖 5(b)所示,閾值電流密度為(wei) 22 KA/cm2。2018 年該研究組基於(yu) Ta2O5/SiO2 雙介質膜 DBR 結構,研究了離子注入電流輸入孔徑結構隧道結內(nei) 腔接觸的 VCSEL [33],實現了室溫連續輸出 140 μW,器件的閾值電流密度為(wei) 42.4 KA/cm2。該研究組又通過優(you) 化外延生長 VCSEL 材料[34],使器件輸出功率提高到 319 μW,閾值電流密度降低至10 KA/cm2。以上這些研究結果均為(wei) 解決(jue) p 型 DBR 導電性差的難題提供了新思路。然而,美國加州大學所采用離子注入孔徑和空氣隙孔徑電流注入孔徑結構的 VCSEL 製備工藝,均需要外延生長設備(MOCVD或 MBE)進行 VCSEL 材料的二次外延生長,在二次外延生長中將會(hui) 引起材料表麵粗糙問題。另外這種電流注入孔徑結構均采用 ITO 膜電極,ITO 膜電極吸收引起的損耗以及 ITO/GaN 界麵帶來的損耗導致閾值電流密度較大。
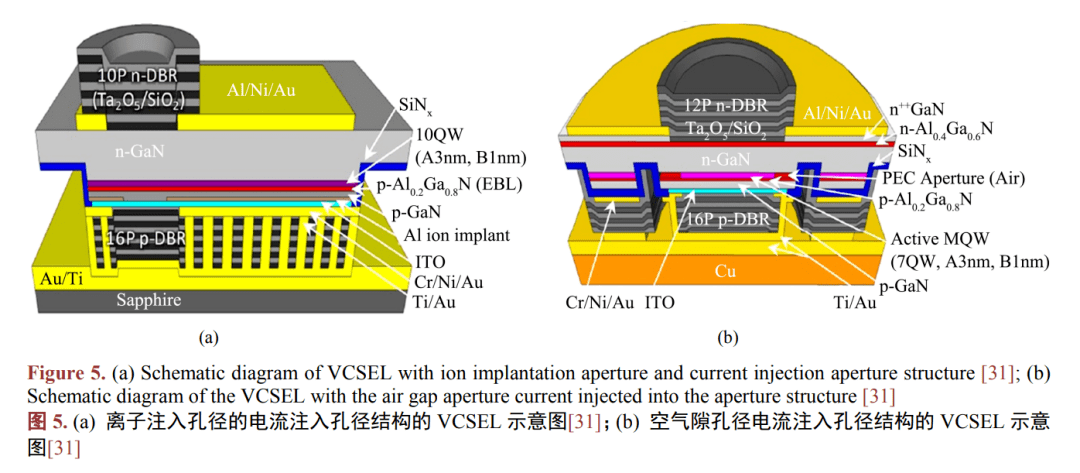
4. 結束語
不斷改進的 VCSEL 電流注入結構能有效地限製側(ce) 向電流的擴散,提高電流注入多量子阱有源區的均勻性,降低器件的閾值電流密度,從(cong) 而實現電注入藍綠光 VCSEL 器件。GaN 基 VCSEL 具有重要的應用前景,推進電注入 GaN 基 VCSEL 的產(chan) 業(ye) 化進展,必將產(chan) 生重大的經濟效益和社會(hui) 效益。目前如何解決(jue) VCSEL 電流注入孔徑的製作難題,突破電注入 GaN 基 VCSEL 的技術瓶頸,為(wei) GaN 基 VCSEL (紫外、藍綠光)的研發提供一種新思路。




轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

