光學表麵的光散射測量方法為(wei) 目前測量光學元件表麵散射特性的一種主要技術,主要包括角分辨測量法和總積分測量法。本文對上述兩(liang) 種測量方法的基本原理和實驗裝置進行了係統的闡述,並對兩(liang) 種方法進行了比較分析。最後討論了散射測量方法發展的趨勢。
隨機粗糙光學表麵的粗糙度是量度光學元件表麵特征的一項重要指標,通常為(wei) 納米量級甚至更低。隨著光學技術的飛速發展及其應用領域的不斷擴大,光學元件表麵粗糙度及其引起的光散射越來越受到人們(men) 的普遍關(guan) 注,已經成為(wei) 光學元件散射特性研究中的基礎和關(guan) 鍵問題之一。利用光散射測量光學粗糙表麵是目前發展較為(wei) 快速和成功的技術,人們(men) 對這種技術做了大量的研究工作,使得光散射係統已經成為(wei) 測量光學元件表麵質量的主要手段之一。概括起來,光學表麵的散射測量方法主要包括角分辨散射測量法和總積分散射測量法,二者分別以矢量散射理論和標量散射理論為(wei) 理論基礎。
1角分辨散射測量法
角分辨散射(AngleResolvedScattering,簡稱ARS)測量法是利用散射光的光強及其分布來測量表麵粗糙度參數。一束激光投射到樣品表麵上後,其鏡向方向的反射光和散射光分布在一個(ge) 半球麵內(nei) ,半球麵內(nei) 各點的光強不同。當表麵非常光滑時,光強主要分布在鏡向方向。表麵越粗糙,鏡向方向的反射光強就越弱,其它點的散射光就越強。用光探測器接收這些不同分布的光強,然後經過統計學和光譜分析或者經過光的反射散射計算,就可以得到被測表麵的粗糙度值。
在ARS測量裝置中,通常以樣品為(wei) 中心,光電探測器圍繞樣品在入射平麵內(nei) 作接近180°或360°的轉動,從(cong) 而測得非入射平麵內(nei) 的散射光。樣品一般能轉動和平動,以測量斜入射下的散射特性和掃描樣品上各點的散射係數。在測量中,散射信號很小,通常要采用鎖相放大器。此外,由於(yu) 測量數據很多,所以常常采用計算機進行自動采集和分析數據。圖1即為(wei) 一種典型的角分辨散射測量儀(yi) 器。
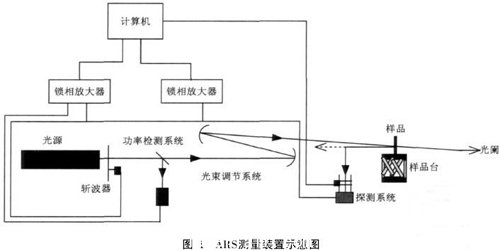
2 總積分散射測量法
在總積分散射(TotalIntegratedScattering,簡稱TIS)測量法中,入射光以很小的入射角照射到隨機粗糙表麵上,用積分球收集粗糙表麵散射的漫反射光或者包含鏡向反射在內(nei) 的總體(ti) 反射光。標量散射理論在微粗糙度條件下建立起了樣品表麵最基本的綜合統計特征參數-均方根(RootMeanSquare,簡稱RMS)粗糙度σ與(yu) 其所有反射方向上的總積分散射TIS之間的關(guan) 係,從(cong) 而使TIS法成為(wei) 一種測量表麵均方根粗糙度的便捷方法。
σ的表達式

可見,TIS與(yu) 反映物體(ti) 表麵不規則起伏程度的RMS粗糙度有關(guan) 。實際工作中,對於(yu) 一般研磨和拋光加工所得到的表麵,其微觀起伏通常具有高斯分布特征,所以根據表麵均方根粗糙度就可以了解表麵微觀形貌的全部統計特征。因此通過測量樣品表麵的總積分散射就可以很方便地得出表麵RMS粗糙度,並且可把它作為(wei) 平麵表麵光滑程度的重要質量指標。
TIS測量裝置主要有兩(liang) 種類型。一種裝有Coblentz半球,即內(nei) 壁鍍有鋁、銀等金屬膜的半球,激光光源垂直照射到置於(yu) 半球後麵的樣品上,被粗糙表麵散射的光強由Coblentz半球采集;另一種是用積分球,光源以微小的角度照射到樣品表麵上,被表麵散射的偏離鏡向反射方向的那部分光強由積分球收集。
圖2所示的總積分散射測量裝置具有Coblentz球,可分別進行背散射或前散射測量,並可分別采用激光器和紫外燈作光源,可測量的波段範圍為(wei) 193nm—10·6μm。此裝置還可以在真空環境或以氮氣為(wei) 淨化氣體(ti) 的條件下對157nm波長進行測量。在背散射測量過程中,利用He-Ne激光器作為(wei) 光源,波長為(wei) 632·8nm。在2—85°的空間範圍內(nei) 被散射到後半球的光強被Coblentz球所收集,然後被成像到探測元件上。光線照射到樣品上的入射角接近於(yu) 零度,鏡向反射光束通過Coblentz球的入射光孔反射出去。
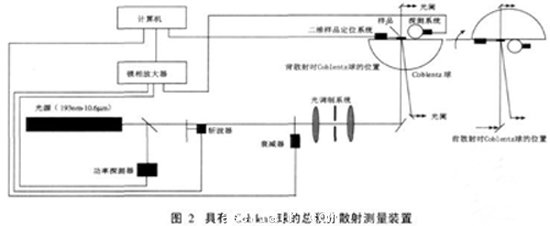
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

