國家科技重大專(zhuan) 項(02)專(zhuan) 家組組長葉甜春先生曾指出:“我國設備產(chan) 業(ye) 發展到現今為(wei) 止,基本以替代為(wei) 主。企業(ye) 了解到某方麵設備我國沒有,那就開始自己製造。但隨著我國半導體(ti) 產(chan) 業(ye) 慢慢崛起,企業(ye) 會(hui) 發現需要采取一些新的方式,例如跟用戶更緊密地結合,和產(chan) 品更緊密聯係,然後再一起做解決(jue) 方案,做一些創新性的解決(jue) 方案。”

圖1 晶圓器件小型化,超薄化發展趨勢
創新性的解決(jue) 方案:
半導體(ti) 設備和材料處於(yu) IC 產(chan) 業(ye) 的上遊,為(wei) IC 產(chan) 品的生產(chan) 提供必要的工具和原料。目前來說,IC 產(chan) 業(ye) 的商業(ye) 模式可以簡單描述為(wei) :IC 設計公司根據下遊客戶(係統廠商)的需求設計芯片,然後交給晶圓代工廠進行製造,之後再由封裝測試廠進行封裝測試,最後將性能良好的IC 產(chan) 品出售給係統廠商。

圖2 IC產(chan) 業(ye) 鏈
隨著晶圓器件朝著微型化、超薄化方向發展,相關(guan) 工藝製程加工難度越來越大,傳(chuan) 統裝備或一貫製程已難以滿足市場對更高加工精度的需求,高良品率得不到保證的問題日趨顯著。
為(wei) 解決(jue) 晶圓器件微型化、超薄化帶來的工藝難題,大族激光顯視與(yu) 半導體(ti) 裝備事業(ye) 部(以下簡稱DSI)聯合國內(nei) 封裝測試行業(ye) 的龍頭企業(ye) 和先進材料供應商,三方共同探討研發。以客戶的產(chan) 品工藝需求為(wei) 中心,反複進行工藝實驗。最後,成功驗證出了最優(you) 化的可行性解決(jue) 方案,即激光拆鍵合技術(Temporary Bonding- Debonding ,TBDB),並申請了國家專(zhuan) 利。由於(yu) TBDB工藝的特殊性,單純銷售設備的方式已不足以滿足客戶需求,DSI在其領先的設備技術基礎上,融入了新的產(chan) 品開發理念,為(wei) 客戶提供設備與(yu) 材料結合的綜合性整體(ti) 解決(jue) 方案,最終贏得了客戶的信任和長期的訂單。
激光拆鍵合技術:
激光拆鍵合技術是將臨(lin) 時鍵合膠通過旋塗的方式塗在器件晶圓上,經過烘烤和高溫加壓下將超薄器件臨(lin) 時粘結到較厚的載片上;臨(lin) 時鍵合後,對其進行背麵加工(包括減薄、TSV加工和金屬化等後續製程),再通過激光掃描的方式,分離超薄器件與(yu) 載片,實現超薄器件的順利加工。最後,再執行清洗工藝。
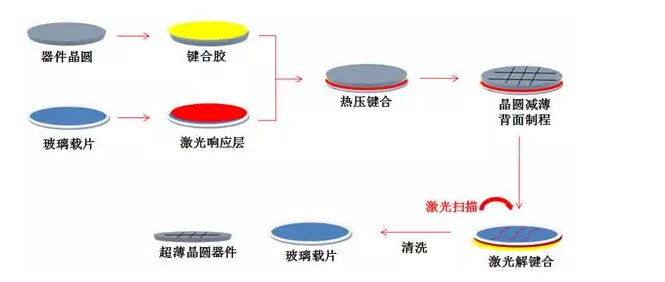

圖3 激光拆鍵合TBDB工藝流程
大族激光半導體(ti) 激光剝離設備(HAN’S DSI-SLLO660)是為(wei) 封裝測試廠提供的一套材料和設備相結合的綜合性解決(jue) 方案。整合了多種激光技術,配合特殊的剝離塗層,從(cong) 而實現晶圓的無損傷(shang) 和高良品率。兼容12英寸(包含8英寸)全自動作業(ye) ,操作更加方便。集成光斑質量監控和反饋,加工更加可靠。


圖4 半導體(ti) 激光剝離設備 HAN’S DSI-SLLO660
關(guan) 於(yu) DSI:
大族激光顯視與(yu) 半導體(ti) 裝備事業(ye) 部(DSI)成立於(yu) 2011年初,聚焦於(yu) 消費電子、半導體(ti) 、LED、麵板等行業(ye) 的精細微加工和相關(guan) 聯行業(ye) 的測量和自動化解決(jue) 方案,主要研究藍寶石、玻璃、陶瓷、矽等脆性材料加工工藝和智能車間解決(jue) 方案;事業(ye) 部在職員工800多人,研發人員占80%以上,2016年事業(ye) 部實現稅後銷售5億(yi) 元。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

