垂直腔麵發射激光器(Vertical cavity surface emitting laser, VCSEL)具有低功耗、小體(ti) 積、圓形對稱光斑及高可靠性等優(you) 點,目前國內(nei) 有多家企業(ye) 在從(cong) 事850nm/940nm/905nm VCSEL相關(guan) 產(chan) 品研發和生產(chan) 。1550nm激光滿足人眼安全要求,在激光雷達、氣體(ti) 探測等領域有廣泛應用前景,但是目前國內(nei) 在1550nm VCSEL商用產(chan) 品研發方麵尚未取得突破。
近日,長光時空聯合長光所王立軍(jun) 院士團隊,研製出高性能1550nm VCSEL芯片。技術人員通過采用高增益應變量子阱,在國內(nei) 首次研發出光功率達到毫瓦量級的單模1550 nm VCSEL。在溫控設定在15 ℃時最高激光功率達到2.6 mW, 邊模抑製比(SMSR)最高達到35 dB,並具有良好的溫度適應性。該項研究以《1550 nm毫瓦級單橫模垂直腔麵發射半導體(ti) 激光器》發表於(yu) 《物理學報》,並被選為(wei) “編輯推薦”論文。
論文鏈接:https://wulixb.iphy.ac.cn/article/doi/10.7498/aps.71.20212132
論文全文
題目 | 1550 nm毫瓦級單橫模垂直腔麵發射半導體(ti) 激光器
1. 引 言
1550 nm波長的激光具有很廣闊的應用前景, 該波長是光纖通信窗口, 在光纖中具有較低的傳(chuan) 輸色散[1]; 1550 nm波長的激光具有高的人眼安全閾值, 不易產(chan) 生人眼損傷(shang) [2]; 另外, 1550 nm波長附近還是一氧化碳、硫化氫等氣體(ti) 的特征吸收波長區域[3]. 發光波長在1550 nm的垂直腔麵發射半導體(ti) 激光器(vertical-cavity surface-emitting laser, VCSEL)具有低功耗、小體(ti) 積、表麵出光及圓形對稱光斑等獨特優(you) 勢, 近年來在低功耗光通信、激光雷達及氣體(ti) 傳(chuan) 感等領域的應用研究獲得了人們(men) 的廣泛關(guan) 注[4,5], 具有廣闊的應用前景. 發光波長在1550 nm附近的VCSEL必須采用InP材料體(ti) 係作為(wei) 發光層. 采用InP襯底生長的晶格匹配材料具有很低的折射率差值, 因而無法用於(yu) 製備低吸收損耗、低電阻的分布布拉格反射鏡(distributed Bragg reflector, DBR)結構[6]. 因此, 目前1550 nm波段的VCSEL一般采用鍵合AlGaAs/GaAs材料的高性能DBR實現光場的垂直振蕩方向控製, 然而鍵合界麵的晶格缺陷及空洞嚴(yan) 重製約著器件的工作性能[7,8]. 近年來, 國外研究機構針對1550 nm波段VCSEL的工作性能提升做了大量研究工作.
早在2003年, 慕尼黑工業(ye) 大學的Gerhard等[9]就論證了1550 nm波段以及更長波段VCSEL的材料製備方案及初步實驗結果. 2009年, 慕尼黑工業(ye) 大學Müller等[10]報道了采用雙麵混合DBR製備1550 nm波段VCSEL的結果, 實現室溫輸出功率為(wei) 1 mW. 隨後, 瑞士聯邦理工學院的Andrei等[11]利用隧道結台階實現了橫向電流限製, 並通過鍵合AlGaAs/GaAs反射鏡, 實現了室溫6.5 mW的連續激射功率. 為(wei) 解決(jue) DBR反射鏡對1550 nm VCSEL的製約, 2013年, 美國加州大學伯克利分校的Connie研究小組[12]引入懸浮式的高對比度光柵反射鏡(high contrast grating, HCG), 實現了15 ℃下單模功率2.4 mW. 隨後, 采用各種新型反射鏡結構替代傳(chuan) 統鍵合反射鏡的技術方案被廣泛研究報道[13,14].
近年來, 隨著高速通信、氣體(ti) 傳(chuan) 感及激光雷達等技術對1550 nm VCSEL的迫切需求, 國內(nei) 也正積極開展1550 nmVCSEL的技術攻關(guan) , 然而在1550 nm波段VCSEL領域的研究報道近乎空白, 主要是由於(yu) 在該波段的材料製備質量和鍵合工藝水平與(yu) 國外具有較大差距. 2020年, 中國科學院半導體(ti) 研究所Liu等[15]報道了采用混合鏡麵反射鏡與(yu) 隧穿結台麵結合的1550 nm VCSEL方案, 其閾值電流為(wei) 20 mA, 激光功率為(wei) 7 μW, 激射譜半高全寬為(wei) 3 nm.
本文報道了1550 nm毫瓦級單橫模VCSEL器件的設計和製備. 首先介紹了1550 nm波段VCSEL的關(guan) 鍵結構量子阱、隧穿結及其橫模特性的設計結果, 其次對VCSEL功率、光譜與(yu) 單模特性等測試結果進行了描述, 最後總結了1550 nm 垂直腔麵發射半導體(ti) 激光器的工作.
2. 器件結構
圖1是本文所用的1550 nm VCSEL的結構示意圖. 該結構主要由上下DBR、隧穿結注入台麵以及量子阱發光區組成. 其中下DBR由30對AlGaInA/AlInAs半導體(ti) DBR與(yu) CaF2/Si介質膜DBR材料共同組成; 上DBR由45對AlGaInA/AlInAs半導體(ti) DBR與(yu) 介質膜DBR材料組成. 發光區由6組6 nm Al0.06Ga0.22InAs量子阱/8 nm Al0.22Ga0.28InAs勢壘層組成. 量子阱發光區與(yu) 上、下DBR之間有約2 μm厚的N型摻雜InP導電層, 以便於(yu) 製備內(nei) 部接觸式的正負電極結構. 為(wei) 實現高的發光區載流子密度, 采用重摻雜的n++/p++隧穿結台麵結構實現空穴在台麵位置的高效注入與(yu) 橫向載流子限製。
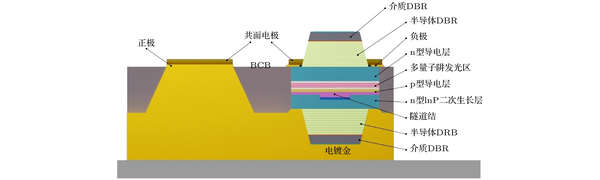
圖 1 1550 nm波段VCSEL結構示意圖
VCSEL的製備工藝流程如下: 采用金屬有機化學氣相沉積外延設備在InP襯底依次生長上半導體(ti) DBR、N型導電層、發光層及隧穿結結構後, 利用幹法刻蝕設備刻蝕出隧穿結台麵, 然後再次生長導電層及下DBR中的半導體(ti) DBR. 之後通過電子束蒸鍍設備蒸鍍下半導體(ti) DBR外部的CaF2/Si介質膜DBR. 製備完成後, 采用電子束蒸金及鍍金設備完成金屬電極製備, 並采用鍵合設備將整個(ge) 結構鍵合到帶有金屬化圖形的透明金剛石薄片上, 以支撐上DBR製備工藝繼續進行. 將InP襯底采用選擇性腐蝕工藝去除後, 繼續刻蝕出台麵結構, 填充BCB材料並利用電子束蒸鍍設備形成金屬電極. 最後在上DBR上蒸鍍介質膜, 完成工藝製備. 為(wei) 了獲取良好的散熱效果, VCSEL的底部電極在工藝過程中被加厚至20 μm以上. 激光器台麵邊緣填充BCB材料的主要目的是實現良好的器件支撐, 確保芯片在操作過程中不易產(chan) 生破損.
3. 理論設計
在半導體(ti) 材料體(ti) 係中, GaInAsP與(yu) AlGaInAs材料均可以作為(wei) 1550 nm波段的發光區材料, 然而AlGaInAs具有更高的導帶帶階(ΔEc/ΔEg), 因而對於(yu) 容易泄漏的載流子電子具有更好的限製效果; AlGaInAs隻有一種V族元素, 因而更容易控製材料的生長質量, 有利於(yu) 實現良好的發光區性能; 同時, 由於(yu) AlGaInAs量子阱相比InP襯底具有張應變效應, 而張應變可以提供更好的能帶分離效果與(yu) 增益水平, 因而AlGaInAs是1550 nm VCSEL理想的量子阱層材料[16]. 圖2是采用的6 nm Al0.06Ga0.22InAs量子阱/8 nm Al0.22Ga0.28InAs勢壘層結構發光區量子阱價(jia) 帶的能級分立情況以及增益譜隨載流子濃度的變化模擬結果。
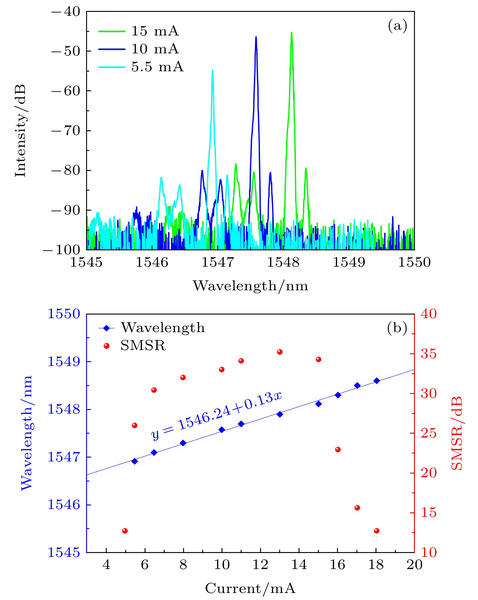
圖 2 (a) 6 nm Al0.06Ga0.22InAs量子阱的價(jia) 帶子能級分布情況; (b)不同載流子濃度下的增益譜變化情況
采用Crosslight軟件中的量子阱增益仿真模塊計算了發光區量子阱價(jia) 帶能級與(yu) 增益譜, 如圖2所示. 圖2(a)中能帶順序自上往下依次是第一重空穴帶(HH1)、第二重空穴帶(HH2)、第一輕空穴帶(LH1)與(yu) 第三重空穴帶(HH3). 價(jia) 帶重空穴帶在上, 有利於(yu) 量子阱在低的電流密度實現粒子數反轉. 第一重空穴帶與(yu) 第二重空穴帶分離良好, 進一步提高了量子阱對注入載流子的限製能力. 由圖2(b)中不同載流子濃度下的增益譜可以看出, 隨著載流子濃度的增加, 增益譜一直較為(wei) 平滑, 並沒有出現第二子能帶光增益. 量子阱增益峰值位置隨載流子濃度增加略有藍移, 這是由於(yu) 載流子的能帶填充效應造成的. 為(wei) 保證工作時增益峰值波長盡量靠近出光波長, 采用的量子阱增益峰位置設定在1.53 μm附近, 比激光波長略短一些. 這是因為(wei) VCSEL工作時, 其內(nei) 部具有較嚴(yan) 重的熱效應, 因而工作時由於(yu) 溫度增加帶來增益峰的紅移, 從(cong) 而最終實現增益峰跟目標激光波長較好匹配[17].
1550 nm波段采用的InP材料結構無法像近紅外波段的GaAs材料一樣通過摻入高Al組分, 實現電流限製層的製備[18], 因而, 目前文獻報道多采用隧穿台麵結構實現載流子的橫向限製. 載流子的隧穿效應是1550 nm VCSEL電流順利注入的關(guan) 鍵. 圖3是采用Crosslight軟件設計的重摻雜隧穿結構的電流-電壓曲線, 隧穿結台麵直徑為(wei) 5 μm. 由於(yu) 隧穿結外加反向偏壓, 因而在電壓小於(yu) 1.5 V時幾乎沒有隧穿電流存在; 而當開啟電壓超出1.5 V, 隧穿電流隨著電壓增加迅速增長, 電壓增長約0.5 V就可以實現10 mA的電流注入, 具有很好的隧穿效果。
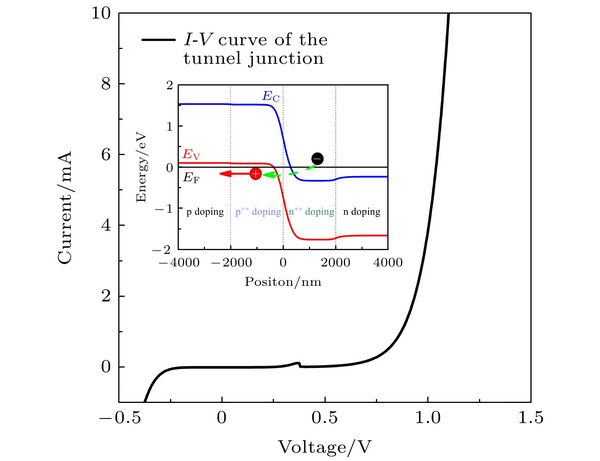
圖 3 隧穿結結構的電流-電壓特性模擬結果, 插圖為(wei) 各隧穿層在1 V偏壓下的能帶結構計算結果及載流子傳(chuan) 輸過程示意圖
圖3插圖為(wei) 模擬的隧穿結材料層在外加偏壓超過開啟電壓後的能帶結構圖. 隧穿結采用n型及p型重摻雜材料, 界麵處重摻雜n型層的導帶與(yu) p型層的價(jia) 帶位於(yu) 同一水平, 因而當電壓繼續增加, n型層的載流子電子直接隧穿至p型層, 實現電流注入, 而不存在額外的勢壘. 這也是隧穿結結構的基本工作原理.
相比近紅外波段常采用的氧化限製結構, 隧穿結結構具有很好的單模工作特性. VCSEL的波導結構屬於(yu) 典型的光纖柱狀波導, 其芯層與(yu) 包層的折射率差值決(jue) 定了基模與(yu) 高階模的分布形式[19]. 對於(yu) 隧穿結結構來說, 其芯層與(yu) 包層的折射率差Δneff = neff-core – neff-cladding較小, 更有利於(yu) 高階模式的耗散與(yu) 基模的增強. VCSEL的Δneff與(yu) 台麵刻蝕深度密切相關(guan) . 對於(yu) 隧穿結台麵, 采用MATLAB自建的光纖模式模型分析了不同刻蝕深度時Δneff以及其對應的單模區直徑變化情況, 如圖4所示. 可以看出, 隨著刻蝕深度增加, Δneff變大, 說明刻蝕深度的增加對波導效應有增強效果, 對應的單模工作區直徑不斷降低. 因而, 刻蝕深度較大時, 對於(yu) 實現大口徑的單模輸出是不利的. 為(wei) 實現5 μm以上的單模工作區直徑, 選擇刻蝕深度不超過100 nm。
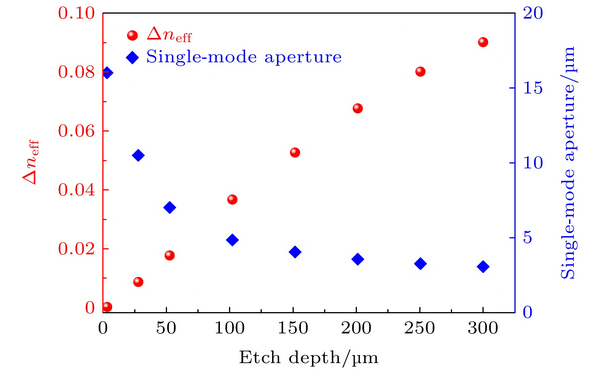
圖 4 隧穿結台麵刻蝕深度對芯層與(yu) 包層的折射率差值Δneff = neff-core-neff-cladding以及單模工作區直徑的影響
4. 實驗結果
製備的1550 nm VCSEL芯片被封裝在TO管殼中, 其底部裝有TEC控溫及NTC測溫元件. 通過改變控溫係統溫度, 測量VCSEL在不同工作溫度下的功率-電流曲線, 測試結果如圖5所示. VCSEL在15 ℃下的熱飽和功率達到2.6 mW. 隨著工作溫度的增加, 最大熱飽和功率快速降低, 在35 ℃下的熱飽和功率仍然可以達到1.3 mW. VCSEL的閾值電流隨溫度的變化趨勢呈現出典型的增益—腔模失配型VCSEL閾值電流特性[20]. 當工作溫度由15 ℃增加到35 ℃後, 熱飽和功率有所降低, 閾值電流也隨之減小, 由15 ℃時的7.4 mA降低到35 ℃時的5.4 mA. 閾值電流隨工作溫度增加而減小, 是因為(wei) 設計的增益峰值波長與(yu) 激光器出光波長相對藍移, 隨著工作溫度的增加, 由於(yu) 增益峰值波長漂移速率比激光器出光波長漂移速率快近一個(ge) 數量級, 因而在較高溫度下實現了增益與(yu) 激光器工作波長的較好匹配. 當工作溫度繼續增加至55 ℃時, 激光器的增益與(yu) 工作波長匹配度仍然較好, 因而VCSEL閾值電流與(yu) 35 ℃相比並無明顯變化. 隨著工作溫度繼續增加至75 ℃, 增益與(yu) 工作波長出現失配, 閾值電流繼續增加. 雖然當工作溫度在75 ℃時VCSEL功率急劇下降, 然而其熱飽和出光功率仍然可以達到0.35 mW.
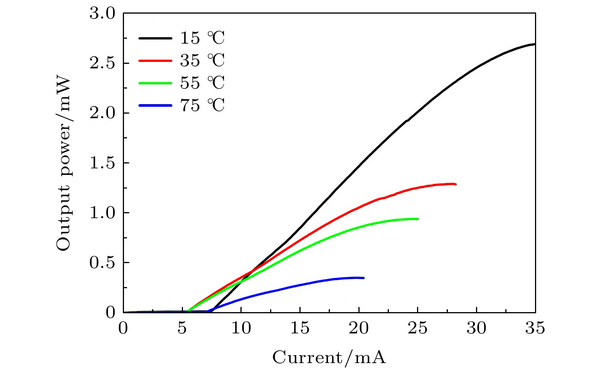
圖 5 不同工作溫度下VCSEL的功率-電流曲線測試結果
圖6(a)給出了工作溫度為(wei) 15℃時, 采用橫河6370D高精度光譜儀(yi) 測得的VCSEL在5.5, 10和15 mA工作電流下的激光光譜. 可以看出, VCSEL在這3個(ge) 工作電流下的激光光譜主峰模式(基模)與(yu) 次級峰模式(高階模)的強度差呈現非常良好的單模輸出特性[21,22]. 當工作電流為(wei) 10 mA時, VCSEL中心波長為(wei) 1547.58 nm, 邊模抑製比(side mode suppression ratio, SMSR)達到了33 dB. 隨著工作電流增加, 出光波長出現紅移現象, 這是因為(wei) VCSEL在工作電流增加時內(nei) 部熱效應增強導致的。
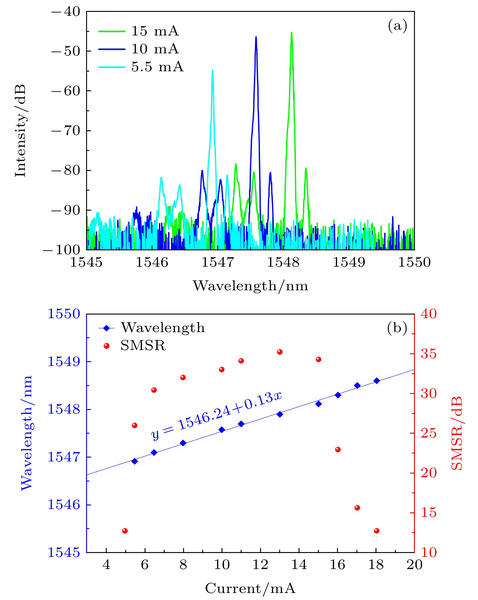
圖 6 工作溫度為(wei) 15 ℃時, (a) VCSEL在不同電流下的單模激光光譜, 以及(b)出光波長與(yu) SMSR隨工作電流的變化關(guan) 係
VCSEL出光波長與(yu) SMSR隨工作電流的變化情況如圖6(b)所示. 當工作電流增加時, VCSEL的出光波長出現紅移. 從(cong) 圖6(b)可以看出, VCSEL的出光波長隨工作電流呈近似線性變化, 波長漂移速率為(wei) 0.13 nm/℃. VCSEL的SMSR參數隨工作電流呈現明顯波動. 工作電流在閾值電流附近(I = 5.5 mA)時, 由於(yu) VCSEL尚未正常激射, 因而其SMSR較低, 僅(jin) 有13 dB. 隨著工作電流增加, SMSR快速增加. 當工作電流為(wei) 13 mA時, VCSEL的SMSR達到最大值35.2 dB. 隨著工作電流超出15 mA, VCSEL的SMSR快速下降. 當工作電流為(wei) 16 mA時, VCSEL的SMSR降至22.9 dB, 與(yu) 文獻[21]中單模VCSEL的結果對比, 此時的SMSR仍高於(yu) 20 dB, 可以認為(wei) VCSEL的激光光譜仍然保持著較好的單模狀態. 根據圖5中的功率-電流曲線, 此時對應的VCSEL激光器單模出光功率為(wei) 0.97 mW. 此後隨著工作電流繼續增加, SMSR數值降至20 dB以下, 激光器為(wei) 多模工作. 更高工作電流下VCSEL單模性變差的主要原因是大電流下VCSEL有源區內(nei) 有更為(wei) 嚴(yan) 重的熱積累. 由於(yu) VCSEL為(wei) 類似光纖模式的波導模型, 在大電流下, 中心區域高的工作溫度使得VCSEL軸向折射率梯度進一步增加, 由此引起激光器對高階模式的導引效應增強, 這使得VCSEL的高階模式在大電流下更容易激射.
5. 結 論
本文報道了1550 nm波長的VCSEL研製結果. 采用高增益發光區量子阱與(yu) 隧穿結台麵結構, 實現了2.6 mW的最大出光功率. 與(yu) 國內(nei) 其他單位報道相比, 在1550 nm波段VCSEL研究中首次突破毫瓦級的激光功率水平; 對VCSEL的單模性進行了測試, 證實其最大單模出光功率可以達到0.97 mW, 此時工作電流為(wei) 16 mA. 由於(yu) 大電流下VCSEL內(nei) 部熱效應嚴(yan) 重, 高階模式波導效應增強, 因而更高工作電流下VCSEL的SMSR數值急劇下降. VCSEL的波長隨工作電流有很好的線性變化, 波長隨電流漂移速率為(wei) 0.13 nm/mA, 這在氣體(ti) 傳(chuan) 感所需的穩定波長調諧方麵將會(hui) 有很好的應用效果. 本文1550 nmVCSEL單元器件的結果為(wei) 下一步通過陣列集成獲得高功率1550 nm VCSEL奠定了基礎. 高功率1550 nm波段VCSEL對於(yu) 解決(jue) 現階段激光雷達的人眼安全問題具有重要意義(yi) .
論文第一作者是長光時空技術總監、長春光機所張建偉(wei) 教授,通訊作者是長光時空總經理張星,論文作者還包括中國科學院王立軍(jun) 院士和寧永強教授。長光時空團隊在王立軍(jun) 院士、寧永強教授的領導下,從(cong) 2002年至今在高性能VCSEL芯片研發和產(chan) 業(ye) 化方麵保持了與(yu) 國外並跑發展。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

