|
薄膜測量係統是基於(yu) 白光幹涉的原理來確定光學薄膜的厚度。白光幹涉圖樣通過數學函數被計算出薄膜厚度。對於(yu) 單層膜來說,如果已知薄膜介質的n和k值就可以計算出它的物理厚度。 AvaSoft-Thinfilm應用軟件內(nei) 包含有一個(ge) 大部分常用材料和膜層n和k值的內(nei) 置數據庫。 AvaSoft-Thinfilm係統可以測量的膜層厚度從(cong) 10nm到50µm,分辨率可達1nm。 薄膜測量廣泛應用於(yu) 半導體(ti) 晶片生產(chan) 工業(ye) ,此時需要監控等離子刻蝕和沉積加工過程。還可以用於(yu) 其它需要測量在金屬和玻璃基底上鍍製透明膜層的領域。其他領域中,金屬表麵的透明塗層和玻璃襯底也需要嚴(yan) 格測量。 AvaSoft-Thinfilm應用軟件能夠實時監控膜層厚度,並且可以與(yu) 其他AvaSoft應用軟件如XLS輸出到Excel軟件和過程監控軟件一起使用。
|
|
 |
|
|
薄膜測量的典型裝置如圖所示 |
|
|
薄膜測量常用配置 |
|
|
光譜儀(yi) |
AvaSpec-2048光譜儀(yi) ,UA光柵(200-1100nm),UV鍍膜,DCL-UV/VIS靈敏度增強透鏡,OSC-200-1100消二階衍射效應鍍膜 |
|
膜層厚度 |
10nm到50µm的膜層,1nm分辨率 |
|
軟件 |
AvaSoft-Thinfilm應用軟件 |
|
光源 |
AvaLight-DHc緊湊型氘-鹵素光源 |
|
光纖 |
1根FCR-7UV200-2-ME反射光纖探頭 |
|
附件 |
THINFILM-STAGE支架,用於(yu) 固定反射光纖探頭 |
轉載請注明出處。






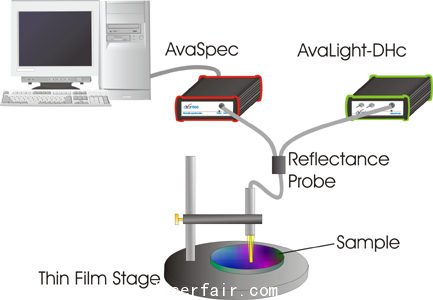

 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀


















 關注我們
關注我們

