由於GaN材料與矽襯底之間存在著巨大的晶格常數失配和熱膨脹係數失配,直接在矽襯底上生長GaN材料會導致GaN薄膜位錯密度高並且容易產生裂紋,因此矽襯底InGaN基激光器難以製備。該研究方向是目前國際上的研究熱點,但是到目前為止,僅有文章報道了在光泵浦條件下矽襯底上InGaN基多量子阱發光結構的激射。
針對這一關鍵科學技術問題,中科院蘇州納米所楊輝研究員領導的III族氮化物半導體材料與器件研究團隊,采用AlN/AlGaN緩衝層結構,有效降低位錯密度的同時,成功抑製了因矽與GaN材料之間熱膨脹係數失配而常常引起的裂紋,在矽襯底上成功生長了厚度達到6 μm左右的InGaN基激光器結構,位錯密度小於6×108 cm-2,並通過器件工藝,成功實現了世界上首個室溫連續電注入條件下激射的矽襯底InGaN基激光器,激射波長為413 nm,閾值電流密度為4.7 kA/cm2。
該項目得到中國科學院前沿科學與教育局、中國科學院先導專項、國家自然科學基金委、科技部重點研發計劃、中科院蘇州納米所自有資金的資助,並且感謝中科院蘇州納米所加工平台、測試平台以及Nano-X在技術上的支持。相關研究成果於8月15日在線刊登在國際學術期刊《自然·光子學》(Nature Photonics)雜誌上(2016年最新影響因子31.167)。
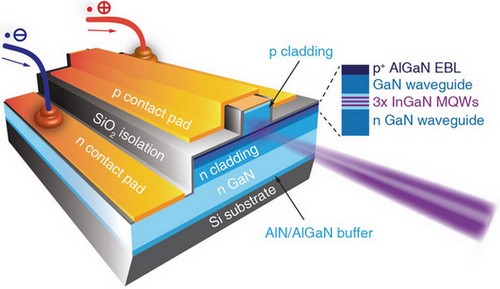
矽襯底InGaN基激光器結構示意圖
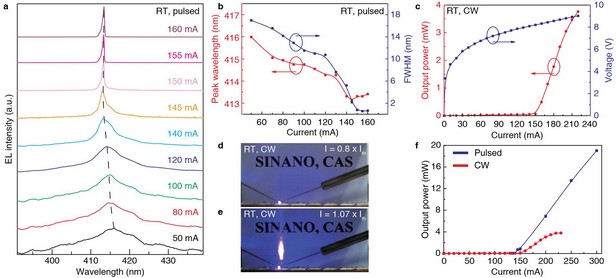
矽襯底InGaN基激光器性能測試結果
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀


















 關注我們
關注我們

