機遇與(yu) 挑戰
近年來,隨著5G、電動汽車、物聯網、AI、雲(yun) 計算等發展,砷化镓、氮化镓、碳化矽等非矽半導體(ti) 材料備受關(guan) 注,新材料、下遊終端的研發與(yu) 應用也逐步被重視,芯片生產(chan) 線的投放量增加,預示封測產(chan) 業(ye) 擁有著較大的市場空間。這給企業(ye) 帶來諸多機遇,同時也麵臨(lin) 著諸多挑戰。目前國內(nei) 封測產(chan) 業(ye) 鏈尚不健全,對國外設備、材料具有很強的依賴性,裝備及材料的國產(chan) 化水平亟待提高。從(cong) 去年的中興(xing) 事件,到今年的華為(wei) 事件,國內(nei) 企業(ye) 都感受到芯片自給自足的重要性、建設半導體(ti) 產(chan) 業(ye) 鏈的必要性和迫切性。
激光技術在先進封裝領域的應用
在本次大會(hui) 上,大族顯視與(yu) 半導體(ti) 李春昊博士以《激光技術在先進封裝領域的應用》為(wei) 主題發表了演講,重點介紹了應用於(yu) 先進封裝領域的激光加工技術及大族顯視與(yu) 半導體(ti) 為(wei) 行業(ye) 提供的激光解決(jue) 方案。
1激光解鍵合技術2017年,全球12寸薄片晶圓出貨量超7500萬(wan) 片;2011年至2017年,每年的增幅在15%左右。隨著元器件朝著小型化、超薄化的發展中,傳(chuan) 統的加工裝備以及傳(chuan) 統的加工工藝很難滿足高精度的加工需求。麵向超薄器件加工領域,大族顯視與(yu) 半導體(ti) 推出紫外激光解鍵合方案。
紫外激光解鍵合技術通過光路整形得到固定大小的激光光斑,利用振鏡或平台對玻璃晶圓麵進行掃描加工。使得release層材料失去粘性,最終實現器件晶圓和玻璃晶圓的分離。
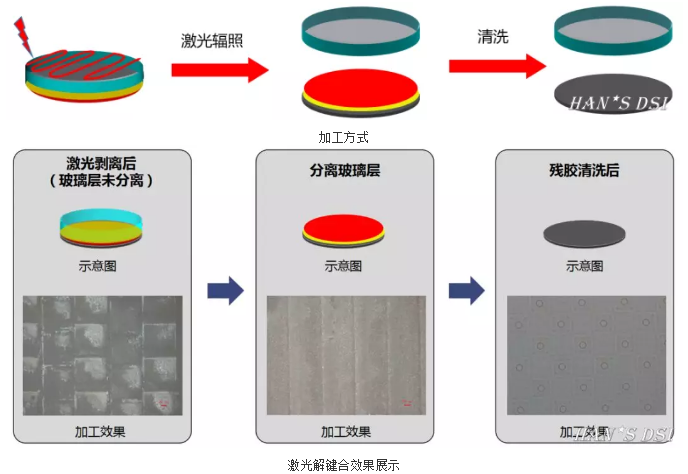
在對表麵具有low-k材料的半導體(ti) 晶圓進行切割分片時,如果采用傳(chuan) 統的刀輪切割方案,極易在low-k層產(chan) 生崩邊、卷翹和剝落等不良;而采用非接觸式的激光加工方案則可以有效避免上述問題。
大族顯視與(yu) 半導體(ti) 開發的超快激光開槽技術,是通過自主研發的光路係統將光斑整形成特定的形貌,聚焦於(yu) 材料表麵達到特定槽型;並利用超快激光極高的峰值功率,將材料從(cong) 固態直接轉化成氣態,從(cong) 而極大的減少熱影響區,是一種先進的激光冷加工工藝製程。

激光改質切割技術適用於(yu) 矽、碳化矽、藍寶石、玻璃、砷化镓等材料。通過將激光束聚焦在晶圓襯底層內(nei) 部,通過掃描形成切割用的內(nei) 部“改質層”,再通過劈刀或真空裂片使相鄰的晶粒斷裂。
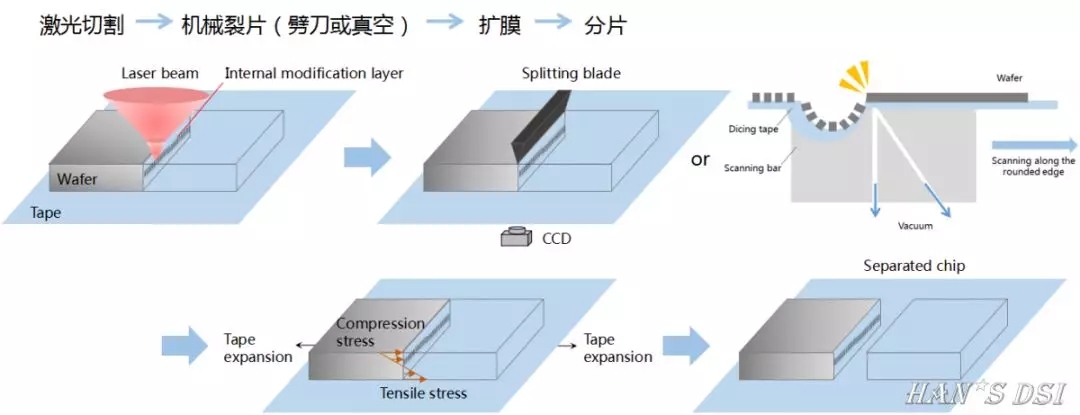
激光改質切割流程
激光改質切割的激光切割寬度幾乎為(wei) 零,有助於(yu) 減小切割道寬度;在材料內(nei) 部進行改質,可以抑製切割碎屑的產(chan) 生,無需塗膠清洗工序。在切割過程中,采用DRA自動對焦,焦點實時跟隨片厚變化而自動調整,確保改質切割的激光聚焦改質層深度一致。
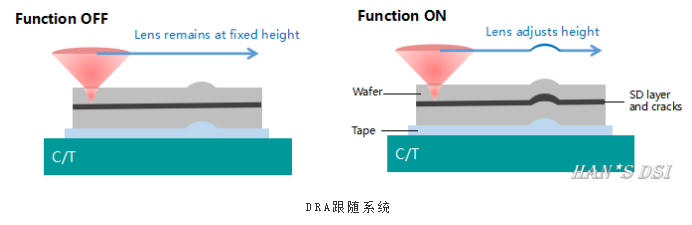
TGV 技術是通過在芯片與(yu) 芯片之間、晶圓與(yu) 晶圓之間製作垂直電極,實現電信號從(cong) 密封腔內(nei) 部垂直引出的工藝。技術廣泛應用於(yu) MEMS 圓片級真空封裝技術領域,在氣密性、電學特性、封裝兼容性與(yu) 一致性以及可靠性方麵獨具優(you) 勢,是實現 MEMS器件微型化、高度集成化的有效方式。
大族顯視與(yu) 半導體(ti) 的TGV技術,采用自主研發的ICICLES技術,光束一致性好,穩定性高;能量利用率高,對激光器要求較低;焦深控製簡單,且技術成熟、應用範圍廣。
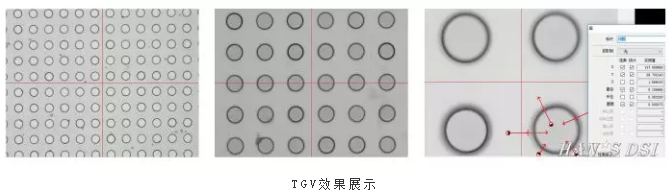
李博在大會(hui) 上重點介紹了以上幾種激光加工技術,除此之外,大族顯視與(yu) 半導體(ti) 還可提供全自動IC打標、刀輪切割、全自動IC卷盤封裝、FT Handler測試分選、晶圓環切等技術解決(jue) 方案。

大族顯視與(yu) 半導體(ti) 解決(jue) 方案
麵對機遇與(yu) 挑戰,大族顯視與(yu) 半導體(ti) 憑借多年在激光領域的技術積累,跟隨市場發展需求,在半導體(ti) 領域陸續取得了一些重大突破,並持續致力於(yu) 在半導體(ti) 行業(ye) 的耕耘,加速裝備國產(chan) 化進程,助力提升中國半導體(ti) 的國際競爭(zheng) 力和影響力。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

