近日,中國科學院上海光學精密機械研究所薄膜光學實驗室在基於(yu) 低溫等離子體(ti) 增強原子層沉積的紫外減反射激光薄膜研究中取得新進展,初步實現了紫外減反射薄膜的損傷(shang) 閾值提升。相關(guan) 研究成果已發表在Journal of Alloys and Compounds上。
原子層沉積技術具有精確的厚度可控性、高均勻性、優(you) 異的共形性和較高的激光損傷(shang) 閾值,在激光薄膜領域具有良好前景。目前,通過熱原子層沉積製備高功率激光薄膜的嚐試主要集中在使用TiO2和Al2O3材料,或者HfO2和Al2O3材料製備近紅外減反射薄膜。利用原子層沉積技術製備紫外減反射薄膜的報道相對較少。大量的電子束激光薄膜研究結果表明,使用HfO2和SiO2材料能夠獲得更高激光損傷(shang) 閾值的紫外減反射薄膜。然而,熱原子層沉積技術製備SiO2所需的沉積溫度較高,不利於(yu) HfO2層的抗激光損傷(shang) 性能。
研究人員采用低溫等離子體(ti) 增強原子層沉積技術,係統研究了SiO2和HfO2薄膜的激光相關(guan) 性能。與(yu) HfO2薄膜相比,SiO2薄膜具有較低的雜質含量與(yu) 吸收,表現出更高的激光損傷(shang) 閾值。這使得低溫等離子體(ti) 增強原子層沉積的SiO2薄膜適合於(yu) 紫外激光應用。他們(men) 設計並采用低溫等離子體(ti) 增強原子層沉積技術製備了一種應用於(yu) 355 nm激光的雙層結構HfO2/SiO2減反射薄膜。該減反射薄膜在355nm的實測反射率低於(yu) 0.2%,激光損傷(shang) 閾值(24.4 J/cm2,脈寬7.8ns)高於(yu) 電子束沉積減反膜薄膜(20.6 J/cm2,脈寬7.8ns)。該項成果有望為(wei) 紫外減反射薄膜的抗激光損傷(shang) 性能提升提供新思路,豐(feng) 富紫外減反射薄膜的製備技術。
相關(guan) 工作得到了國家自然科學基金、中科院青年創新促進會(hui) 、上海市青年拔尖人才計劃、中科院戰略性先導科技專(zhuan) 項等的支持。
論文鏈接
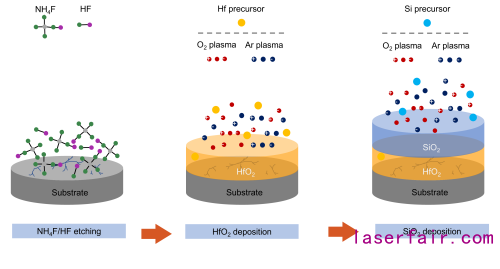
圖1 低溫PEALD技術沉積HfO2/SiO2紫外減反膜示意圖

圖2 等離子體(ti) 增強原子層沉積(PEALD)和電子束沉積(E-beam)減反射薄膜的性能對比。(a)反射光譜,(b)膜層吸收,(c)激光損傷(shang) 概率。
轉載請注明出處。








 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀


















 關注我們
關注我們

