晶片切割是半導體(ti) 器件製造中的重要一環,切割方式和切割質量直接影響到晶片的厚度、粗糙度、尺寸及生產(chan) 成本,更會(hui) 對器件製造產(chan) 生影響巨大。碳化矽作為(wei) 第三代半導體(ti) 材料,是促進電氣革命的重要材料。高質量的結晶碳化矽的生產(chan) 成本非常高,人們(men) 往往希望將一個(ge) 大的碳化矽晶錠切成盡可能多的薄碳化矽晶片襯底,同時工業(ye) 的發展使晶片尺寸不斷增大,這些都讓人們(men) 對切割工藝的要求越來越高。但是碳化矽材料的硬度極高,莫氏硬度為(wei) 9.5級,僅(jin) 次於(yu) 世界上最硬的金剛石(10級),同時又兼具晶體(ti) 的脆性,不易切割。目前工業(ye) 上一般采用砂漿線切割或金剛石線鋸切割,切割時在碳化矽晶錠的周圍等間距的固定線鋸,通過拉伸線鋸,切割出碳化矽晶片。利用線鋸法從(cong) 直徑為(wei) 6英寸的晶錠上分離晶片大概需要100小時,切出來的晶片不僅(jin) 切口比較大,表麵粗糙度也較大,材料損失更是高達46%。這增加了使用碳化矽材料的成本,限製了碳化矽材料在半導體(ti) 行業(ye) 的發展,可見對碳化矽晶片切割新技術的研究迫在眉睫。
近年來,激光切割技術的使用在半導體(ti) 材料的生產(chan) 加工中越來越受歡迎。這種方法的原理是使用聚焦的激光束從(cong) 材料表麵或內(nei) 部修飾基材,從(cong) 而將其分離。由於(yu) 這是一種非接觸式工藝,避免了刀具磨損和機械應力的影響。因此,它極大提高了晶圓表麵的粗糙度和精度,還消除了對後續拋光工藝的需要,減少了材料損失,降低了成本,並減少了傳(chuan) 統研磨和拋光工藝造成的環境汙染。激光切割技術早已經應用於(yu) 矽晶錠的切割,但在碳化矽領域的應用還未成熟,目前主要有以下幾項技術。
1、水導激光切割
水導激光技術(Laser MicroJet, LMJ)又稱激光微射流技術,它的原理是在激光通過一個(ge) 壓力調製的水腔時,將激光束聚焦在一個(ge) 噴嘴上;從(cong) 噴嘴中噴出低壓水柱,在水與(yu) 空氣的界麵處由於(yu) 折射率的原因可以形成光波導,使得激光沿水流方向傳(chuan) 播,從(cong) 而通過高壓水射流引導加工材料表麵進行切割。水導激光的主要優(you) 勢在於(yu) 切割質量,水流不僅(jin) 能冷卻切割區,降低材料熱變形和熱損傷(shang) 程度,還能帶走加工碎屑。相較線鋸切割,它的速度明顯加快。但由於(yu) 水對不同波長的激光吸收程度不同,激光波長受限,主要為(wei) 1064nm、532nm、355nm三種。
1993年,瑞士科學家Beruold Richerzhagen首先提出了該技術,他創始的Synova公司專(zhuan) 門從(cong) 事水導激光的研發和產(chan) 業(ye) 化,在國際上處於(yu) 技術領先地位,國內(nei) 技術相對落後,英諾激光、晟光矽研等企業(ye) 正在積極研發。

圖1. 水導激光切割技術
2、隱形切割
隱形切割(Stealth Dicing, SD)即將激光透過碳化矽的表麵聚焦晶片內(nei) 部,在所需深度形成改性層,從(cong) 而實現剝離晶圓。由於(yu) 晶圓表麵沒有切口,因此可以實現較高的加工精度。帶有納秒脈衝(chong) 激光器的SD工藝已在工業(ye) 中用於(yu) 分離矽晶圓。然而,在納秒脈衝(chong) 激光誘導的SD加工碳化矽過程中,由於(yu) 脈衝(chong) 持續時間遠長於(yu) 碳化矽中電子和聲子之間的耦合時間(皮秒量級),將會(hui) 產(chan) 生熱效應。晶圓的高熱量輸入不僅(jin) 使分離容易偏離所需方向,而且會(hui) 產(chan) 生較大的殘餘(yu) 應力,導致斷裂和不良的解理。因此,在加工碳化矽時一般采用超短脈衝(chong) 激光的SD工藝,熱效應大大降低。
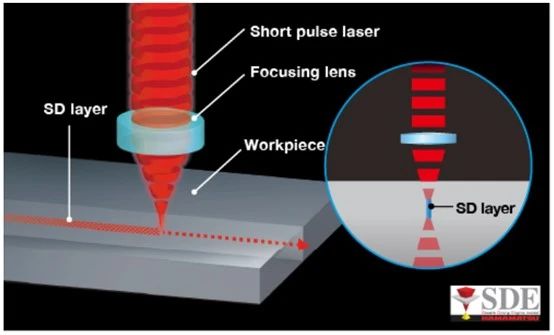
圖2. 激光隱形切割
日本DISCO公司研發出了一種稱為(wei) 關(guan) 鍵無定形黑色重複吸收(key amorphous-black repetitive absorption, KABRA)的激光切割技術,以加工直徑6英寸、厚度20 mm的碳化矽晶錠為(wei) 例,將碳化矽晶圓的生產(chan) 率提高了四倍。KABRA工藝本質是上將激光聚焦在碳化矽材料的內(nei) 部,通過 “無定形黑色重複吸收”,將碳化矽分解成無定形矽和無定形碳,並形成作為(wei) 晶圓分離基點的一層,即黑色無定形層,吸收更多的光,從(cong) 而能夠很容易地分離晶圓。

圖3. KABRA晶圓分離
被英飛淩收購的Siltectra公司研發的冷切割(Cold Split)晶圓技術,不僅(jin) 能將各類晶錠分割成晶圓,而且每片晶圓損失低至80μm,使材料損失減少了90%,最終器件總生產(chan) 成本降低多達30%。冷切割技術分為(wei) 兩(liang) 個(ge) 環節:先用激光照射晶錠形成剝落層,使碳化矽材料內(nei) 部體(ti) 積膨脹,從(cong) 而產(chan) 生拉伸應力,形成一層非常窄的微裂紋;然後通過聚合物冷卻步驟將微裂紋處理為(wei) 一個(ge) 主裂紋,最終將晶圓與(yu) 剩餘(yu) 的晶錠分開。2019年第三方對此技術進行了評估,測量分割後的晶圓表麵粗糙度Ra小於(yu) 3µm,最佳結果小於(yu) 2µm。

圖4. 冷切割技術
國內(nei) 大族激光研發的改質切割是一種將半導體(ti) 晶圓分離成單個(ge) 芯片或晶粒的激光技術。該過程同樣是使用精密激光束在晶圓內(nei) 部掃描形成改質層,使晶圓可以通過外加應力沿激光掃描路徑拓展,完成精確分離。

圖5. 改質切割工藝流程
目前國內(nei) 廠商已經掌握砂漿切割碳化矽技術,但砂漿切割損耗大、效率低、汙染嚴(yan) 重,正逐漸被金剛線切割技術迭代,與(yu) 此同時,激光切割的性能和效率優(you) 勢突出,與(yu) 傳(chuan) 統的機械接觸加工技術相比具有許多優(you) 點,包括加工效率高、劃片路徑窄、切屑密度高,是取代金剛線切割技術的有力競爭(zheng) 者,為(wei) 碳化矽等下一代半導體(ti) 材料的應用開辟了一條新途徑。隨著工業(ye) 技術的發展,碳化矽襯底尺寸不斷增大,碳化矽切割技術將快速發展,高效高質量的激光切割將是未來碳化矽切割的重要趨勢。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

