隨著5G通信、新能源汽車和電子產(chan) 品的快速發展,功率半導體(ti) 器件的需求顯著增長。第一代和第二代半導體(ti) 材料的工藝逐漸逼近其物理極限,摩爾定律也逐漸失效。在此背景下,第三代半導體(ti) 技術有望突破傳(chuan) 統技術的瓶頸,成為(wei) 第一、二代半導體(ti) 的有力補充。碳化矽(SiC)作為(wei) 第三代半導體(ti) 材料,因其具備寬帶隙、高擊穿電場、高電子遷移率以及優(you) 良的熱導率等特性,展現出廣泛的應用潛力。
從(cong) 碳化矽原材料到功率半導體(ti) 器件的製造涉及多個(ge) 關(guan) 鍵步驟,包括單晶生長、晶錠切割、外延生長以及晶圓設計、製造和封裝等工藝。SiC粉末經過合成後,首先製備成碳化矽晶錠,隨後通過切片、研磨、拋光和清洗等流程製成碳化矽襯底。接著,通過外延生長形成外延片,再經光刻、刻蝕、離子注入和金屬鈍化等工序製造出SiC晶圓。最終,通過晶圓劃片工藝得到芯片,並進一步封裝成功率器件。
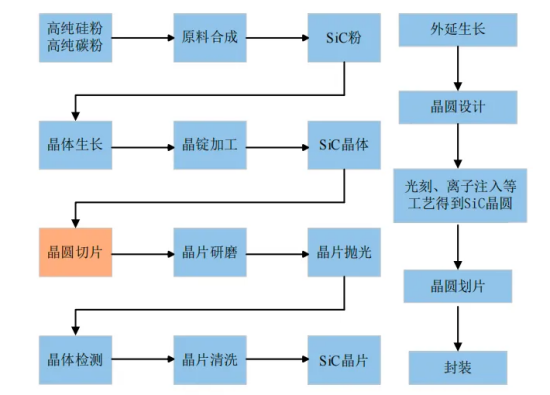
碳化矽半導體(ti) 功率器件工藝圖 圖源:公開網絡
在這些工藝中,晶體(ti) 生長和晶圓切割是最為(wei) 關(guan) 鍵的環節,約占整個(ge) SiC器件製造成本的47%。這兩(liang) 個(ge) 步驟技術門檻高,附加值大,也是實現SiC大規模產(chan) 業(ye) 化的核心所在。由於(yu) 碳化矽具有極高的硬度(莫氏硬度超過9,僅(jin) 次於(yu) 金剛石)、較大的脆性以及良好的化學穩定性,成為(wei) 加工難度較大的材料之一。
當前,工業(ye) 界在SiC晶錠切割中應用了多種工藝,包括金剛石線鋸切割、受控剝落、電火花切割及激光切割等。其中,金剛石線鋸和刀片切割最為(wei) 常見。這類傳(chuan) 統機械切割方法具有成本低廉、設備要求簡單、易於(yu) 實現大規模生產(chan) 的優(you) 點,同時金剛石切割工具相對易於(yu) 獲取。然而,傳(chuan) 統SiC機械切割仍存在諸多問題,如刀具磨損嚴(yan) 重、晶片易產(chan) 生裂紋、表麵粗糙度較高以及切縫損耗較大等。為(wei) 解決(jue) 這些問題,研究人員仍需不斷探索新型切割工藝和工具,以進一步提升切割質量和效率。
激光輔助脆性材料切片技術的相關(guan) 研究
自20世紀60年代第一台激光器問世以來,激光技術得到了不斷的發展,衍生出多種類型的激光器,廣泛應用於(yu) 醫療、通信、光存儲(chu) 等領域。進入21世紀後,超快激光技術迅速發展,逐步催生了皮秒、飛秒和阿秒級激光。然而,阿秒激光由於(yu) 成本高昂,尚處於(yu) 實驗室研究階段,未能得到大規模的應用。
在碳化矽(SiC)晶錠的切片加工中,傳(chuan) 統的機械切割方法仍是工業(ye) 界的主流。為(wei) 提高加工質量和效率,研究人員不斷提出創新方法,嚐試將先進工藝與(yu) 傳(chuan) 統切割技術相結合,改進刀具性能,或開發新的加工工藝。例如,Hiroto Maeda等人通過結合高速多線鋸與(yu) 電鍍金剛石絲(si) 進行SiC晶錠切割,成功實現了每分鍾0.6毫米的高速切割,發現提高線材速度和增加金剛石濃度有助於(yu) 減少切割損傷(shang) 。Lun Li等人則通過實驗和數值分析研究了超聲激勵線鋸切割的運動特性,並建立了SiC單晶的有限元仿真模型。Lutao Yan等為(wei) 了提升金剛石線鋸的切割性能,采用三維超聲振動輔助切割,並利用仿真模型預測了切削力,發現超聲振動能夠顯著降低橫向和縱向的切削力。Norimasa Yamamoto等提出了一種旋轉式電火花切割工藝,成功切割了2英寸的SiC晶錠,並將切割損耗控製在350微米左右。Yoshida Masahiro等人對比分析了油水型電火花切割SiC的加工特性,得出水型電火花切割的去除率比油型高出1.1倍,但切縫損耗高30%,表麵粗糙度增加了3倍。
雖然上述研究在一定程度上改進了切割速度和表麵粗糙度,但傳(chuan) 統線鋸切割仍存在切縫損耗較高(材料損耗超過45%)、表麵粗糙度Ra超過3.4微米,以及難以進行超薄晶圓切片的不足。
為(wei) 克服這些問題,超短脈衝(chong) 激光因其獨特的加工優(you) 勢成為(wei) SiC晶錠切割的理想選擇。它能夠避免傳(chuan) 統機械切割中切縫材料的浪費以及刀具與(yu) 晶片直接接觸導致的高表麵粗糙度問題。Marko Swoboda等人首次提出了激光輔助晶圓冷裂工藝,通過激光掃描在預定厚度位置形成損傷(shang) 層,再利用晶錠表麵塗覆的高分子材料在驟冷環境下裂片,成功用於(yu) Si、藍寶石和熔融石英等材料的剝離。李斌等人通過激光冷分離技術對SiC晶棒進行切割,分析了該工藝的關(guan) 鍵難點,認為(wei) 激光加工是最核心的環節。Wenhao Geng等人結合飛秒激光與(yu) 帶隙選擇性PEC刻蝕法,對4H-SiC進行剝離,利用能量差實現了HF溶液中的選擇性損壞。Kosuke Sakamoto等人開發了一種基於(yu) 皮秒激光的金剛石切割技術,通過限製裂紋在{111}解理麵方向擴展,成功實現了沿{100}方向的裂紋控製。Hanwen Wang等人研究了表麵預處理對4H-SiC激光加工與(yu) 剝離的影響,發現預處理能有效提升切片質量。Eunho Kim等人利用800 nm、1 kHz的雙脈衝(chong) 飛秒激光對4H-SiC進行了掃描剝離,成功獲得了均方根粗糙度為(wei) 5微米、切削損耗小於(yu) 24微米的剝離表麵。
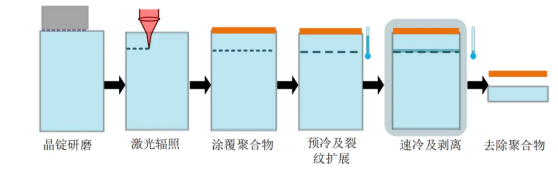
激光輔助晶圓冷裂工藝 圖源:公開網絡
隱形切割技術與(yu) 激光輔助晶圓切割技術有許多相似之處,二者均通過激光在材料內(nei) 部形成損傷(shang) 層。在激光輔助晶圓切割過程中,隱形切割技術對改性層的形成具有重要的參考價(jia) 值。然而,隱形切割中的損傷(shang) 層裂紋需要沿著激光的入射方向擴展,而激光輔助晶圓切割中的裂紋則沿著與(yu) 激光入射和掃描方向垂直的方向擴展。
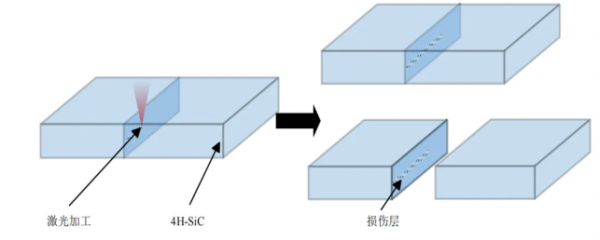
隱形切割工藝 圖源:公開網絡
關(guan) 於(yu) 隱形切割技術,已有大量研究成果
例如,Qiuling Wen等利用紅外皮秒激光對4H-SiC進行了隱形切割,分別在Si麵和C麵沿{1120}和{1100}方向進行激光掃描加工,隨後采用三點彎曲法劈裂。研究發現,沿{1120}方向改性後的臨(lin) 界斷裂載荷小於(yu) 沿{1100}方向的改性,表明切割質量和臨(lin) 界斷裂載荷與(yu) 晶體(ti) 取向密切相關(guan) 。Caterina Gaudiuso等使用脈寬200 fs、波長1030 nm的激光設備對石英進行隱形切割,分析了激光參數對切割效果的影響,並揭示了其機理。研究指出,激光在石英內(nei) 部聚焦加工時,產(chan) 生的壓縮應力鬆弛後導致拉應力,從(cong) 而在焦點附近引發微小裂紋,使材料能夠沿激光傳(chuan) 播方向剝離。
Zhaoqing Li等通過20°軸向凸透鏡產(chan) 生高度均勻的貝塞爾光束,對藍寶石進行了隱形切割,分析了貝塞爾光束掃描速度對藍寶石薄片抗彎強度及側(ce) 壁粗糙度的影響。Kai Liao等利用皮秒激光的貝塞爾光束對二氧化矽玻璃進行隱形切割,分析了點間距、激光功率及離焦距離等參數對材料橫截麵粗糙度的影響,發現離焦距離是影響切割質量的主要因素。Z-Q. Li等通過飛秒激光貝塞爾光束對石英玻璃進行隱形切割,在0.5毫米和1毫米厚的石英玻璃上成功實現了垂直切割,且切割過程中無切縫損耗、切割表麵無碎屑和裂紋。
劉成群等通過對比隱形切割與(yu) 傳(chuan) 統機械劃切,深入分析了隱形切割中的激光參數,並介紹了該技術在MEMS器件晶圓劃片中的應用。宋燕國等利用高能皮秒激光對SiC晶圓進行隱形切割,調整激光參數以觀察表麵形貌、邊緣直線度及表麵粗糙度等,最終確定了最佳的切割參數,驗證了其切割質量優(you) 於(yu) 其他研究成果。
Peng Liu等人通過結合飛秒激光與(yu) 光纖激光器的多焦點分離係統,開發了激光多焦點分離技術(LMFS),成功分離了厚度達50毫米的KDP晶體(ti) ,展示了超短脈衝(chong) 激光在脆性材料分離中的卓越表現。Leimin Deng等人則通過雙激光束分離(DLBS)技術提升了KDP晶體(ti) 分離的質量和尺寸控製,展示了該技術在精密分離領域的潛力。
上述研究表明,超短脈衝(chong) 激光在脆性材料加工中的應用潛力巨大,特別是在通過精確控製激光參數以實現高質量分離和切割方麵,具有顯著優(you) 勢。超短脈衝(chong) 激光輔助SiC晶圓切片技術正是這種應用的典型代表。由於(yu) SiC具有高硬度和脆性,傳(chuan) 統的機械切割方法容易導致裂紋和表麵粗糙度高等問題,而超短脈衝(chong) 激光切割能夠避免這些缺陷,確保超薄晶圓切割的精度,同時顯著降低表麵粗糙度和切縫損耗,從(cong) 而大幅提升加工質量和效率。盡管該技術具有顯著優(you) 勢,近年來針對其在SiC晶圓切割中的研究報道仍較為(wei) 稀少,值得進一步關(guan) 注和深入研究。(來源:DT半導體(ti) )
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

