隨著近幾年電子產(chan) 品(手機、筆記本電腦、平板)和車載玻璃(特別是電動汽車)的不斷大幅度的更新換代,對與(yu) 玻璃采用激光切割的方式也越來越多,今天在這裏簡要的梳理一下我們(men) 常見的幾種激光切割方式。
其實激光切割玻璃的大規模普及應用,應該追溯到5年前蘋果的指紋識別蓋板(home鍵)和攝像頭蓋板的應用,材質使用的是藍寶石材質,然後再普及至國產(chan) 手機的一部分指紋識別蓋板,藍寶石或者陶瓷材質,再然後藍寶石熱度下降之後,國產(chan) 手機創新性的用鋼化玻璃完美的替代了藍寶石材質,使得成本得以大幅度的下降和普及。

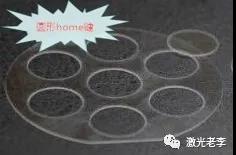



最早期的藍寶石玻璃切割,通常采用的是光纖激光器+切割頭的傳(chuan) 統方式來進行切割,比較適合大片切中片(圓形或者方形)的一個(ge) 工藝流程,中片開出來後,再用紅外皮秒激光器+振鏡的一個(ge) 切割方式來進行激光切割小片,這種方式基本上持續了2年時間,當然,這種製程工藝同樣適用與(yu) 陶瓷(氧化鋯陶瓷)激光切割一個(ge) 工藝製程,而陶瓷的開中片工藝,也同樣可以采用CO2激光器+切割頭的一個(ge) 搭配組合,但是,中片切小片,同樣也是采用的紅外皮秒激光器+振鏡的切割方式。此為(wei) 傳(chuan) 統的激光表切工藝。




激光表切的工藝,類似激光打標機的一個(ge) 工作原理,就是在精密激光切割的軟件內(nei) ,畫出來指定型號規格的圖形,根據皮秒激光器的最小線寬,來一層一層剝離掉藍寶石或者陶瓷表麵的材料,從(cong) 而形成相應的切割道,直致產(chan) 品完全切透,也叫激光剝離,再用治具把小片吸取出來即可。

這種表切的製程工藝相對成熟,因為(wei) 皮秒激光器的頻率調節範圍廣,單點能量高,所以可以輕鬆的剝離掉產(chan) 品,最小線寬足夠小,所以,崩邊量可以控製在20-30μm以內(nei) ,基本可以滿足小片產(chan) 品的工藝製程。但是,此種表切的工藝,範圍不能做大,目前常規的應用在60mm*60mm範圍之內(nei) ,再往上去的範圍的話,受限與(yu) 目前紅外皮秒激光器100瓦激光能量的限製條件和遠心鏡頭的工作範圍的條件限製,未發現市場上有更大範圍的工作區域。
其實,還有一個(ge) 重要因素就是,50瓦以上的紅外皮秒激光器,進口都是受限的,基本上都是來自德國通快或者美國相幹公司等一些國外公司,特別是100瓦的紅外皮秒激光器,我們(men) 國內(nei) 廠商要拿到這種高功率的紅外皮秒激光器,因為(wei) 貿易壁壘和技術壁壘的原因,價(jia) 格高,交期基本上都在3個(ge) 月左右,這個(ge) 是對我們(men) 國內(nei) 激光行業(ye) 來說是個(ge) 大問題,咱們(men) 國內(nei) 就算買(mai) 人家的激光器有問題點,也無權維修和維護。技不如人,就需要更加努力學習(xi) ,好在國內(nei) 已經在低功率的紅外皮秒激光器上出現了國產(chan) 替代(<50瓦皮秒激光器),距離皮秒激光器的普及應用,將有深刻的意義(yi) 。
下圖這家夥(huo) 可不便宜,而且還得小心點伺候著,得需要恒溫空調房,過段時間還得給它用藥水清洗清洗,老金貴了,關(guan) 鍵這玩意老外還不一定樂(le) 意賣給你。

另外,紅外皮秒激光器行業(ye) 內(nei) 普遍使用的是雙工位操作,就是把一台激光器進行光路的分光後,分別使用2套振鏡和2套鏡頭,2套治具,輪流切割,這樣可以大幅度的提高效率,同時,也是自動化上下料的一個(ge) 必然步驟。
為(wei) 什麽(me) 還說受限與(yu) 鏡頭的範圍內(nei) ,根本的原因就是:當用大鏡頭的時候,範圍大了,但是,分配到激光單點的能量就相對弱了很多,造成用大鏡頭無法剝離材料的情況,現在目前使用最多的就是100瓦紅外皮秒激光器和50瓦紅外皮秒激光器,也是條件受限的一個(ge) 原因。
采用紅外皮秒激光器+振鏡的方式進行表切工藝,因為(wei) 是用鏡頭聚焦激光,就自然而然的必然存在一個(ge) 角度的問題點,行業(ye) 內(nei) 稱之為(wei) 錐度的問題點,0.3mm的藍寶石為(wei) 例,采用此種表切的激光切割工藝,一般錐度能控製在13°已經很好。
隨著大家對皮秒激光器的應用了解,我們(men) 在應用的過程中發現了一個(ge) 非常有意義(yi) 的一個(ge) 技術,行業(ye) 內(nei) 稱之為(wei) 貝塞爾光束,也有叫一刀切技術,這個(ge) 工藝其實可以嚴(yan) 格定義(yi) 為(wei) 表切和隱切中間的一種柱狀切割工藝,目前還未有一個(ge) 明確的名稱,就我個(ge) 人而言,是偏向與(yu) 是一種隱切的工藝。

為(wei) 何我個(ge) 人認為(wei) 是一種隱切工藝呢?因為(wei) 貝塞爾光束的核心工藝原理還是在透明材料中間形成一種很小局部的熱熔現象,而且目前我們(men) 已知的皮秒激光器內(nei) ,也隻有紅外皮秒能產(chan) 生貝塞爾光束現象,而綠光皮秒和紫外皮秒激光器,均無法形成貝塞爾光束的效應。
而行業(ye) 內(nei) 稱之為(wei) 表切和隱切中間的一種柱狀切割工藝,其實就是利用了紅外皮秒的一種熱熔現象,表切工藝的核心就是從(cong) 材料表麵進行一層一層剝離,隱切工藝的核心就是在材料中間層麵進行定向的爆破點,而貝塞爾光束是在材料中間層麵進行熱熔,是即兼顧了表切工藝也兼顧了隱切工藝,現在就看大家如何去定義(yi) 它了?
有了此技術之後,我們(men) 對與(yu) 玻璃、藍寶石、矽等透明材料的激光切割就又多了一種選擇,僅(jin) 限透光材料,在此再次明確一下:貝塞爾光束切割,僅(jin) 限透光材料。
而貝塞爾光束激光切割機的切割方式是配備的激光切割頭,這樣無論是平台移動還是激光切割頭移動,都極大的方便了激光切割任意圖形,由於(yu) 此類加工方式在材料內(nei) 部的切割,且激光能量的一個(ge) 高斯分布狀態,我們(men) 完全可以在切割過程中的0錐度和極小的崩邊量(行業(ye) 內(nei) 一般為(wei) <10μm),這樣就大大的改善了表切工藝的工藝痛點。我們(men) 用貝塞爾光束激光切割機切割完材料之後,可以輕鬆的用裂片機對材料進行裂片,或者在玻璃加工過程中的一個(ge) 氫氟酸浸泡工藝的一個(ge) 應用,這樣大大的優(you) 化了工藝製程。另外一個(ge) 極大的優(you) 勢就是,采用此類加工工藝,不會(hui) 存在激光表切工藝的粉塵汙染,無需進行清洗工藝。
常見的貝賽爾激光切割機的工藝流程為(wei) :1、貝塞爾激光切割中片——裂片——成品包裝,常用於(yu) 藍寶石切割工藝;2、貝塞爾激光切割中片——鋼化——氫氟酸浸泡——裂片——成品包裝,常用於(yu) 鋼化玻璃切割工藝;

下麵我們(men) 再簡要的說一下激光的隱切工藝,隱切,顧名思議就是隱形切割,也就是激光在材料中間層定向的進行縱向爆破點,從(cong) 而形成一個(ge) 材料中間的切割道,再用裂片機在切割道進行裂片即可。因為(wei) 激光聚焦在材料中間層,所以稱之為(wei) 激光隱切。當然,也有叫激光改質的。
激光隱形切割是運用多光子吸收的光學損傷(shang) 現象來完成切割,當激光掃描在透明材料中間位置時,聚焦在材料內(nei) 部的激光強度迅速增強材料即被加工,從(cong) 而在材料內(nei) 部形成一個(ge) 改質層(也有叫SD 層),使材料由結構緊湊、結合緊密的不易於(yu) 分斷的整體(ti) 改變成結合鬆散、易於(yu) 分斷的脆整體(ti) (有的叫打破分子鍵),所以有的叫激光改質,再用裂片機將透明材料裂開即可。




目前我們(men) 常用的激光隱切工藝,主要是濾光片、晶圓、LED襯底、SiC等材料,激光隱形切割的更多應用範圍,還需要我們(men) 去進行更廣泛的拓展,目前在半導體(ti) 應用領域是主流。由於(yu) 激光隱形切割在材料中間層的原理,所以,應用也是隻能在透明材料領域,另外,超過1mm厚度的透明材料,因為(wei) 需要在材料內(nei) 部形成縱向的切割道,必須使用多次切割的一個(ge) 工作,所以,太厚的材料,我們(men) 目前不建議使用激光隱切工藝。
激光改質層或者SD層,會(hui) 延縱向進行一個(ge) 微應力,但是,這個(ge) 定向爆破點,也一定會(hui) 產(chan) 生橫向的微應力,為(wei) 了避免橫向的微應力,目前在激光隱切工藝上,很少用到高功率的激光器,我們(men) 常規的應用就是幾瓦的一個(ge) 超快激光器的應用。
另外,激光隱切工藝的一個(ge) 在材料中間產(chan) 生縱向應力的特點,所以,我們(men) 必須加裂片工藝才能將材料裂開,所以,目前的激光隱切工藝都是切割的直線或者放射線,想切任意圖形,不是滿足不了切割,而是無法進行裂片。目前受限領域也在此。
而激光隱切目前的最重要領域就是半導體(ti) 行業(ye) 領域,傳(chuan) 統的是用DISCO的刀輪劃片,隨著先進封裝領域的進步,刀輪劃片的切割道至少在40μm以上,且無可避免的會(hui) 對芯片產(chan) 生粉塵汙染,而且刀輪切割的崩邊也較大(通常>50μm),且需要不斷的用水循環來冷切金剛刀,隻能進行濕式製程,且金剛刀價(jia) 格也不菲,耗材嚴(yan) 重,根本無法滿足現如今的先進半導體(ti) 製程。
而激光隱形切割,則完美的解決(jue) 了如上問題,全幹式製程,無需清洗,切割道控製在幾個(ge) μm以內(nei) ,崩邊也控製在幾個(ge) μm以內(nei) ,速度是傳(chuan) 統刀輪切割的20倍以上,這就是技術的完美替代。美中不足的就是采用激光隱切工藝,無法滿足厚片製程,1mm以上的就不要考慮激光隱切了,另外,激光隱切工藝對材料表麵的粗糙度也有一定的要求,粗糙度越高,越會(hui) 對激光隱切產(chan) 生漫反射,粗糙度越低,越對激光隱切越有利。下圖粗糙度Ra<0.07μm與(yu) Ra>0.07μm矽片切割後的Si片切割效果對比,請仔細看右麵粗糙度大的效果,是不是特別差。

所以,在未來的先進半導體(ti) 領域,激光隱形切割將大行其道,最大化的利用材料的產(chan) 出比。
綜上所述,我們(men) 對常規脆性材料的激光切割,主要分為(wei) 3大類:激光表切、激光隱切、貝塞爾光束激光切割。
激光表切的工藝,我們(men) 可以理解為(wei) 激光打標機的原理,隻是更換成了皮秒激光器或者飛秒激光器而已,還有必須加振鏡,一層一層掃下去的材料,有一定的錐度和崩邊(錐度一般<13°,且視材料厚度來定,崩邊一般<30μm);
激光隱切和貝塞爾光束激光切割,都是針對透明材料領域,激光隱切一般用低功率的紅外皮秒激光器,采用隱切是激光打點在材料內(nei) 部,形成一個(ge) 定向的縱向爆破點,從(cong) 而形成縱向的應變力,加裂片後可以輕鬆裂開,此工藝可以做到0錐度和極小的崩邊量(通常<5μm);
貝塞爾光束激光切割也是針對透明材料領域,則用高功率的紅外皮秒激光器,且隻有紅外皮秒激光器在透明材料上能產(chan) 生貝塞爾光束的柱狀分布,激光聚焦在材料中間層,通過熱熔的一種方式,形成縱向和橫向的爆破點,從(cong) 而改變材料的分子鍵,或者叫打破材料的分子鍵,也是必須加裂片工藝才能裂開,可以實現0錐度切割,且崩邊控製量也很好(通常<10μm),需要增加裂片工藝。
不同點就是激光隱切隻能切割直線或者拋物線,貝塞爾光束激光切割則可以切割任意圖形,隻是這2種激光切割的應用領域和裂片工藝有所區別而已。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

