摘要:由於(yu) 需以各種非金屬半導體(ti) 材料晶圓製造使用價(jia) 值低之微電子產(chan) 品,對其加工高精度及品質改善的要求更為(wei) 嚴(yan) 苛,因此研究效率高的晶圓切割方法有其必要性。本文將探討得以加工昂貴複雜之裝置的高效晶圓切割法,筆者透過實驗證明應用激光控製熱裂解法的效果,提出將該方法導入玻璃、矽、藍寶石及其他脆性非金屬材料精密切割的優(you) 勢與(yu) 成果。
關(guan) 鍵詞:微電子產(chan) 品;激光切割半導體(ti) 材料;激光切割晶圓;激光切割玻璃;激光控製熱裂解法(韓卓申科切割法)
俄羅斯科學與(yu) 創新發展的趨勢為(wei) 對微米和納米技術領域之研發,並將其結果導入生產(chan) 。
由於(yu) 現代電子產(chan) 品發展突飛猛進,使儀(yi) 器和工藝設備尺寸縮小。微米和納米技術與(yu) 製造微米、納米物體(ti) 的方法直接相關(guan) ,其尺寸至少在一個(ge) 維度上不大於(yu) 100µm或100nm。為(wei) 製造以微米和納米技術為(wei) 基礎之電子產(chan) 品,采用的是經充分驗證之材料及新材料,擁有廣大潛力能為(wei) 特定應用取得可控製、有利的物理化學性質。
用於(yu) 生產(chan) 半導體(ti) 器件之傳(chuan) 統晶圓材料均屬脆性,而印刷其上的結構因物理特性加深後續生產(chan) 製程難度。此外,精密器件加工複雜促使收益增加、開發更為(wei) 繁複的結構,並優(you) 化半導體(ti) 晶圓有效區域之應用,同時又要維持售價(jia) 與(yu) 運營成本。
目前將晶圓分離成芯片的主要技術皆建立於(yu) 機械與(yu) 激光切割基礎上,即鑽石劃線後裂片、帶外刀刃的鑽石圓盤鋸片切割、激光劃線後裂片、激光切割等。
本文分析非金屬材料晶圓的切割技術和方法,闡述芯片品質研究結果,並特別著重激光控製熱裂解(Laser Controlled Thermal Cracking,以下簡稱LCT)[1-4]及其在製造各式電子產(chan) 品的應用[5]。
1 現有晶圓切割技術與(yu) 設備分析
首先探討鑽石劃線後裂片,以及帶外刀刃的鑽石圓盤鋸片切割。
半導體(ti) 晶圓機械劃線直至1990年代未曾改變[6],刀具有硬質合金刀輪、三角錐或四角錐台等形式,皆以鑽石及其他硬質合金製成,因其耐磨性最佳。機械劃線用角錐的稜劃線,輪流標示刻槽,此法的應用受限於(yu) 有如應力集中係數k之標準,透過施加彎矩決(jue) 定在表麵的最大彎曲應力,可經下列公式計算:
k = (0.355 (t - d) / r) + 0.85) / 2 + 0.08 | (1) |
其中,t:晶圓厚度;d:切割深度;r:鑽石粒徑。
由此可知,晶圓愈厚所需的彎曲應力愈大。可透過增加劃痕深度減少所需的彎曲應力,但如此沿切割線的缺陷程度便會(hui) 增加,且劃線工具上壓力提高可能導致材料分裂不受控製;另可加大鑽石粒徑,但同樣會(hui) 影響芯片斷麵品質及其機械強度。
半導體(ti) 晶圓機械劃片和分割的設備廠商有法國JFP及Cefori、台灣愛玻麗(li) 工業(ye) 、英國Loadpoint等公司。
在生產(chan) 中最簡易的晶圓切割法為(wei) 鑽石圓盤鋸片切割。當切割深度不超過1.5 mm,可使用帶外刀刃的鑽石圓鋸片將晶圓切割分離成芯片[7]。有時采用間隔距離與(yu) 欲切割芯片尺寸相等的鋸片組,或用配備雙軸之機器。根據不同任務,圓盤厚度為(wei) 0.02~0.32 mm(20~320 µm)不等。鑽石圓盤切割之目的旨在實現寬度20 µm的鋸痕,然而,卻更常出現寬度達250 µm的鋸痕,關(guan) 鍵在於(yu) 刀片材料、鑽石顆粒粒度和密集度、旋轉與(yu) 切割速度等眾(zhong) 多因素。
帶外刀刃的鑽石圓盤鋸片切割缺點為(wei) 刀具硬度G不高,該部分主要取決(jue) 於(yu) 其尺寸(含厚度和外徑)的比例,而硬度與(yu) 主要操作因素相關(guan) ,如下列關(guan) 係式:
 (2)
(2)
其中,Km:(用來說明材料性質的)係數;W:轉數;Vcut:切割速度;m, n:常數。
強化刀具硬度的方式有二:其中一種為(wei) 采用厚切割鋸片,但將加大鋸口寬度並增加材料損失;另一種則為(wei) 提高切割鋸片轉速,此時產(chan) 生之離心力會(hui) 給予額外的硬度,但隨著轉數增多,鋸片刀刃產(chan) 生振動,流體(ti) 力學過程加強,也會(hui) 導致切割區域缺陷數量、大小皆增加。
製造切割晶圓的外刀刃鑽石圓盤鋸片設備和工具廠商有:ESTO(俄羅斯)、PLANAR(白俄羅斯)、Loadpoint(英國)、ADT先進切割科技(以色列)、迪思科及東(dong) 京精密(日本)等。
相較於(yu) 機械法,透過激光劃線及切割晶圓的方法仍處於(yu) 發展階段。隨著晶圓直徑加大、激光器更為(wei) 便宜且產(chan) 能增長,其生產(chan) 優(you) 勢也顯著提升。
本文將探討激光切割晶圓的許多研究,包含使用具有各種波長範圍輻射[8, 9]、不同脈衝(chong) 寬度(飛秒、皮秒至納秒[10-13])與(yu) 功率之激光。惟上述加工皆未將切割厚度200µm以上的晶圓列入考慮。
已確知脈衝(chong) 頻率愈高,切割速度愈快,為(wei) 材料內(nei) 部能量分布增加所致。然每一發脈衝(chong) 燒蝕深度的增加會(hui) 引發如熔化、裂紋、非晶化和殘餘(yu) 應力積累等熱影響。將晶圓分離為(wei) 芯片時,這些熱影響導致芯片強度降低,損壞表層薄膜與(yu) 敏感的電子器件。
激光劃線時,切割道寬達2.5~100 µm,取決(jue) 於(yu) 輻射源、光學儀(yi) 器及其他輔助係統;而速度變化可在5~300 mm/s範圍內(nei) ,決(jue) 定性因素為(wei) 加工材料之性質、厚度及其他參數。為(wei) 順利對劃線後之材料進行機械劈裂,劃線深度必須超過材料厚度的30%,例如,日本迪思科公司官網即有激光劃線和激光切割非金屬材料設備介紹[14]。
有一項新技術是用激光透過熱衝(chong) 擊對材料引起可控製的破壞。約莫13年前,由日本濱鬆公司開發出來並取得專(zhuan) 利之「隱形切割法」在晶圓切割實際應用上前景可期。此方法是將部分透明的激光光斑聚焦在板材內(nei) 部接近晶圓表麵之處,並沿著預定方向對材料引發可控製的破壞。當材料內(nei) 部具備的功率密度足夠,會(hui) 形成一條微裂紋、點缺陷的線,與(yu) 製作紀念品的玻璃半成品內(nei) 部3D激光打標雷同[15],且如同任一種劃線法,施加內(nei) 部缺陷後必須再進行劈裂作業(ye) 。
原則上隱形切割法因具備速度快、零汙染、切割寬度近乎為(wei) 零等優(you) 點,而被視為(wei) 理想的晶圓切割解決(jue) 方案。據各方資料顯示,隱形切割速度可高達600 mm/s,關(guan) 鍵因素在於(yu) 材料及其厚度、激光器功率參數。
2 激光控製熱裂解法(LCT法、韓卓申科切割法、Kondratenko切割法)
80年代範德米爾.史戴潘諾維奇.韓卓申科教授在蘇聯發明LCT法[16],過去用於(yu) 製造光電子玻璃產(chan) 品。然而,近十年多種脆性非金屬材料的激光控製熱裂解法迅速發展,並應用在各科技領域。許多關(guan) 於(yu) LCT法應用的出版品,以及發展該方法與(yu) 製造成套工藝設備的專(zhuan) 利[1-4]皆可證實該論點。
LCT製程基礎是激光光斑沿晶圓切割線進行加熱,隨後再以致冷劑冷卻受熱處。激光輻射照射材料表麵會(hui) 使外層產(chan) 生顯著的壓縮應力,但不會(hui) 造成斷裂。正因致冷劑促使局部劇烈冷卻,所形成之溫度梯度導致表麵層產(chan) 生拉伸應力,才得以使裂紋推進(如圖1)。
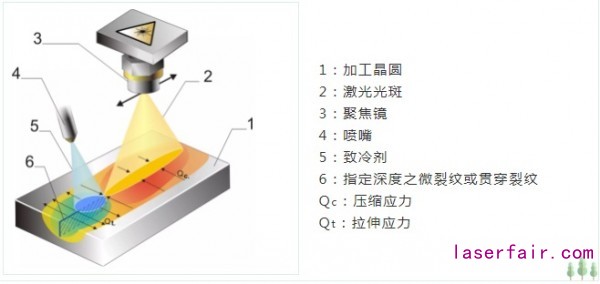
圖1 以LCT法生成微裂之示意圖
加熱和冷卻之選配旨在於(yu) 指定深度(占晶圓厚度10~50%處)形成微裂紋,或是直接切穿。此外,相較於(yu) 傳(chuan) 統方法,切割速度也提高了多個(ge) 數量級──厚度較薄的產(chan) 品速度更可能超過1000 mm/s;由於(yu) 前述性能,全世界首次將激光切割導入浮法玻璃之生產(chan) [17,18]。浮法玻璃係指鋪在錫液表麵上的熔融玻璃,全球多達80%平板玻璃皆以該方式製成,其切割通常采機械法,所形成之微裂紋及其他缺陷致使強度下降50~60%。
LCT法除了生產(chan) 效率極高、絕無缺陷(裂紋或缺口)之外,強度亦高於(yu) 傳(chuan) 統方法五倍之多[19, 20]。材料不論厚薄均能以LCT技術切割,如厚達20 mm之玻璃或僅(jin) 50μm之薄藍寶石晶圓[21-23]品質均優(you) 。無論直線或異形切割,铌酸鋰、鉭酸鋰、碳化矽、砷化镓、微晶玻璃、陶瓷、玻璃、石英或甚至鑽石的斷麵皆相當完美及平滑[24]。由於(yu) 毫無缺陷,也便不需保留餘(yu) 量以處理刀具遺下之缺陷。如由莫斯科廠藍寶石開放式股份公司生產(chan) 的RT-350和RT-500激光控製熱裂解設備[25-27]用於(yu) 晶圓切割,即為(wei) 實現此方法之一例。
運用LCT法切割脆性材料時,邊緣強度比機械或激光劃線高出5~5.5倍,且不會(hui) 對集成電路的技術操作參數產(chan) 生負麵影響[28-30]。相對於(yu) 傳(chuan) 統切割法無疑具有極大優(you) 勢,但以LCT法沿交叉線切割有一定難度。LCT後高強度、無缺陷的晶圓斷麵阻止裂紋在原切割線相交處推進,因而開發出得以克服此限製之方案,並獲取專(zhuan) 利權[3, 4]。
韓卓申科教授是鴻海科技集團的科學顧問,該集團為(wei) 生產(chan) 蘋果公司電子產(chan) 品及旗艦小配件的全球領導者。利用LCT法開發切割玻璃及藍寶石產(chan) 品的技術設備為(wei) 其主要合作方向。鴻海科技集團2007年即成立研究生產(chan) 車間,後發明以萬(wan) 用技術設備執行異形激光切割和雙麵倒角的製程[31-33],用於(yu) 與(yu) 蘋果公司iphoness、ipads和iMac等移動設備相似的防護屏(如圖2)。

圖2 移動設備防護屏
俄羅斯綠城TM激光和設備公司根據與(yu) 專(zhuan) 利權人簽訂之許可協議,導入在俄應用LCT技術所累積的經驗。2014年出產(chan) 之MLP1-1060/355試生產(chan) 設備(如圖3)即適用於(yu) 藍寶石與(yu) 其他脆性非金屬材料晶圓LCT切割[34]。
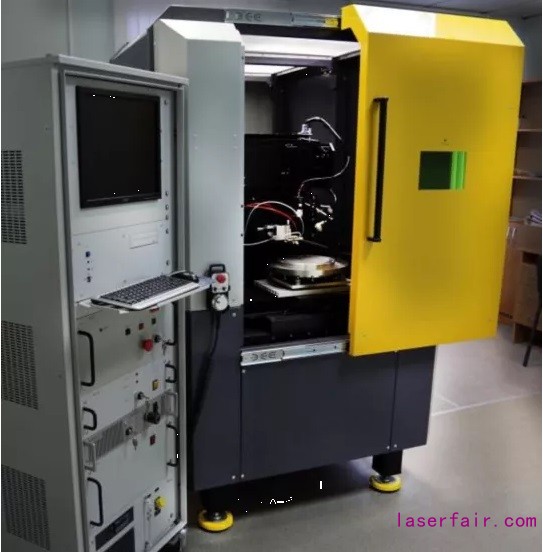
圖3 俄羅斯設備MLP1-1060/355
取LCT法切割晶圓後所得之藍寶石芯片斷麵照片進行比較(如圖4),可見LCT明顯優(you) 於(yu) 其他熟知的競爭(zheng) 技術;其切割速度介於(yu) 30~500 mm/s間,視藍寶石厚度(30~1000 μm)而定。一般來說,藍寶石在一個(ge) 工藝周期內(nei) 即一刀切穿,僅(jin) 在某些情況下會(hui) 於(yu) 占材料厚度10~30%處先行作出初始微裂,再以激光或機械劈裂完成切割,如藍寶石防護屏閉環切割便建議依前述方式操作。
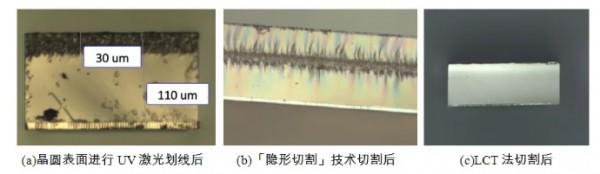
圖4 厚110μm的藍寶石芯片斷麵
接續探討以LCT法解決(jue) 有機發光二極體(ti) (Organic Light Emitting Diode,以下簡稱OLED)矽晶圓切割質量的問題,尤以生產(chan) 微型顯示器為(wei) 主[8, 35-37]。以玻璃基板封裝並帶有OLED的切割用矽晶圓成本相當高。
OLED微型顯示器領域的先驅有eMagine(美國)、索尼(日本)、MicroOLED(法國)、奧雷德(中國)和TOPE Ltd.(俄羅斯)等製造商,采行傳(chuan) 統方法將矽晶圓切割成芯片,然即便最佳工藝參數也無法對OLED芯片進行品質管理,因而借助LCT開發新的激光切割法,可由反麵加工用防護玻璃封裝之矽晶圓。以感光度範圍介於(yu) 1460~1625 nm(矽透射率»55%)的紅外線攝像機沿切割線瞄準,以便識別矽晶圓工作麵上用於(yu) 對位的參考標記。矽經韓卓申科切割法一刀切穿後OLED結構不會(hui) 受損[38,39],切割時不致過熱,斷麵光滑,而邊緣也毫無缺陷。
將鑽石圓盤鋸片及LCT切割後之芯片斷麵品質進行比較,並以型號XP-200的Ambioses(美國)表麵光度儀(yi) 測量芯片工作斷麵的表麵粗糙度(如圖5),鋸片切割後為(wei) Rа= 23.407 μm,而LCT後則不大於(yu) Rа~0.005μm。

圖 5 芯片斷麵照及其表麵輪廓圖
3 結論
將LCT法導入生產(chan) 以半導體(ti) 晶圓為(wei) 基底的防護屏、顯示麵板和現代電子產(chan) 品等製程,可提高生產(chan) 率及合格率。此成果來自LCT法相對於(yu) 競爭(zheng) 技術之主要優(you) 勢,即:
(一) 沿切割線無缺陷,可由粗糙度值證明,通常超越競爭(zheng) 對手多個(ge) 數量級。
(二) 由於(yu) 邊緣無缺陷,與(yu) 傳(chuan) 統技術相比,LCT之後產(chan) 品機械強度高出5倍之多。
(三) 製程速度快,實際能力較其他方法高出數倍。
(四) 晶圓工作表麵上各元件和結構不會(hui) 惡化或改變。
如今,韓卓申科切割法創始人及支持者持續在各行業(ye) 和研究中將此技術發揚光大,如英屬開曼群島商納諾股份有限公司便致力於(yu) 各種脆性非金屬材料切割技術,以及新一代設備之開發、拓展與(yu) 導入。
1俄羅斯科技大學物理與(yu) 技術學院光學暨生物工程係統與(yu) 技術教研室,莫斯科 107996
E-mail:vsk1950@mail.ru
2國際技術科學院,莫斯科 127051
3有機和印刷電子技術股份有限公司,莫斯科 107497
E-mail:ivi061@gmail.com
4英屬開曼群島商納諾股份有限公司材料激光加工實驗室,台北11493
E-mail: jasber@nanoplustech.com(呂鴻圖)
lasercutan@163.com(納烏(wu) 莫夫 A S)
wynadya@nanoplustech.com(王薇媛)
參考文獻:
[1] [俄]韓卓申科VS. 非金屬材料切割法:俄羅斯聯邦,2024441[P].1992-04-02.
[2] [英]韓卓申科VS. 非金屬材料切割:國際專(zhuan) 利,WO93/20015[P].1993-10-14.
[3] [俄]韓卓申科VS. 脆性非金屬材料切割法(延續性專(zhuan) 利):俄羅斯聯邦,2206528[P].2001-08-15.
[4] [俄]韓卓申科VS,納烏(wu) 莫夫AS.脆性材料晶圓切割法:俄羅斯聯邦,2404931[P].2009-08-28.
[5] [俄]韓卓申科VS.創新項目商業(ye) 化[J].機器製造的節奏,2016,1:50.
[6] [俄]尼基芙羅娃-丹尼索娃SN.機械及化學加工:半導體(ti) 器件及微電子產(chan) 品技術第四冊(ce) [M].莫斯科:高等學校,1989:96.
[7] [俄]庫爾諾索夫AI,尤金VV.半導體(ti) 器件與(yu) 集成電路生產(chan) 技術:「半導體(ti) 及絕緣體(ti) 」和「半導體(ti) 器件」專(zhuan) 業(ye) 高等學校教材[M].3版,改寫(xie) 增訂版.莫斯科:高等學校,1986:368.
[8] [俄]伊萬(wan) 諾夫VI.用於(yu) 生產(chan) 有機發光微型顯示器的矽晶圓切割法[J/OL].科學學,2014,4(23). http://naukovedenie.ru/PDF /87TVN414.pdf.
[9] [英]曾XJ,毛X,格裏夫R,等.矽的紫外飛秒和納秒激光燒蝕:燒蝕效率和激光誘導等離子體(ti) 膨脹[C/OL]//克勞德RP.高功率激光燒蝕V:光電儀(yi) 器工程師協會(hui) 論文集.第5448卷.2004. https://dx.doi.org/10.1117/12.544401.
[10] [英]博瓦茨J,帕特爾R.以納秒脈衝(chong) 355nmQ開關(guan) 激光源及線聚焦注量優(you) 化技術進行薄矽晶圓高速切割[C/OL]//弗雷金 W,呂 Y,鷲尾 K,等.以激光為(wei) 基礎的微米和納米級封裝及組裝IV:光電儀(yi) 器工程師協會(hui) 論文集.第7585卷.2010. https://dx.doi.org/10.1117/12.845298.
[11] [英]邦斯J,鮑達奇S,克魯格J,等.矽的飛秒激光燒蝕--變質閾值與(yu) 型態[J/OL].應用物理學A輯.2002,74:19–25. https://link.springer.com/article/10.1007/s003390100893.
[12] [英]拉邱凱提斯G,布裏卡斯M.矽和玻璃的皮秒激光微加工[C/OL]//宮本I,赫爾瓦簡H,伊藤K.第五屆激光精密微加工國際研討會(hui) :光電儀(yi) 器工程師協會(hui) 論文集.第5662卷.2004:717. https://dx.doi.org/10.1117/12.596604.
[13] [英]克洛茨巴赫U,潘茲(zi) 納M,卡斯珀J,等.以摻釹釔鋁石榴石激光及諧波成像加工矽[C/OL]//杜博夫斯基JJ,霍文W,杉岡(gang) K,等.微電子學與(yu) 光子學中的光子處理:光電儀(yi) 器工程師協會(hui) 論文集.第4637卷.2002:496. https://dx.doi.org/10.1117/12.470659.
[14] [英]迪思科高科技股份有限公司.產(chan) 品信息[OL].[2018-10-29].https://www.disco.co.jp/eg/products/laser/index.html.
[15] [英]濱鬆公司.隱形切割技術及應用[OL].2005[2018-10-29].
[16] [俄]韓卓申科VS. 切割平板玻璃的方法:俄羅斯聯邦,776002[P].1979-02-19.
[17] [俄]韓卓申科VS,鮑裏索夫斯基VE,金丁PD.浮法玻璃激光切割技術開發與(yu) 應用[J].莫斯科國立儀(yi) 器工程與(yu) 電腦科學大學學報,2006,7:73–81.
[18] [俄]韓卓申科VS,日馬洛夫AB,索利諾夫VF,等.浮法玻璃製程中的激光切割[J].玻璃與(yu) 陶瓷,2006,10:3–5.
[19] [俄]韓卓申科VS,索利諾夫VF,塔納謝楚克AS,等.以各種方法激光加工玻璃邊緣的產(chan) 品強度[J].電子業(ye) ,1988,1(69):30–31.
[20] [俄]韓卓申科VS,柯比什NI,納烏(wu) 莫夫AS,等.玻璃邊緣加工法對產(chan) 品強度之影響[C]//科學、技術與(yu) 教育當中的創新工藝:國際科學技術會(hui) 議論文集.莫斯科:莫斯科國立儀(yi) 器工程與(yu) 電腦科學大學,2009:60–65.
[21] [俄]韓卓申科VS,馬什維奇PR,米納耶夫VV.藍寶石晶圓激光控製熱裂解[C]//電子係統耐輻射性能:科技論文集.莫斯科:國立核能研究大學莫斯科工程物理學院,2009,12:228.
[22] [俄]韓卓申科VS,納烏(wu) 莫夫AS.藍寶石晶圓激光切割新技術[J].儀(yi) 表設備,2011,10(136):37–41.
[23] [英]韓卓申科VS,鮑裏索夫斯基VE,納烏(wu) 莫夫AS.藍寶石晶圓激光切割新技術[J].先進材料研究,2013,660:30–34.
[24] [英]韓卓申科VS,鮑裏索夫斯基VE,納烏(wu) 莫夫AS.優(you) 化異形切割玻璃激光控製熱裂解之參數[J].光學與(yu) 光子學雜誌,2015,5(10):295–302.
[25] [俄]韓卓申科VS,鮑裏索夫斯基VE,納烏(wu) 莫夫AS,等.晶圓激光切割機[J].儀(yi) 表設備,2006,4(70):38–43.
[26] [俄]韓卓申科VS,金丁PD,科列斯尼克VD,等.半導體(ti) 晶圓激光切割機RT-350[C]//科學、技術與(yu) 教育中的創新工藝:國際科學技術會(hui) 議論文集.莫斯科:莫斯科國立儀(yi) 器工程與(yu) 電腦科學大學,2009:9.
[27] [俄]韓卓申科VS,金丁PD,納烏(wu) 莫夫AS,等.RT-500玻璃激光切割機[C]//科學、技術與(yu) 教育中的創新工藝:國際科學技術會(hui) 議論文集.莫斯科:莫斯科國立儀(yi) 器工程與(yu) 電腦科學大學,2009:10.
[28] [俄]沙夫魯克NV,馬爾切夫PP,韓卓申科VS,等.厚300 µm以上的藍寶石晶圓切割[C]//第六屆物理與(yu) 納米異質結構超高頻電子學技術國際科研實用會(hui) 議「馬克羅夫紀念講座」論文集.莫斯科:國立核能研究大學莫斯科工程物理學院,2015:54–55.
[29] [俄]甘克雷利茲(zi) SA,韓卓申科VS,斯帝藍VV,等.已開發之藍寶石及碳化矽晶圓切割基本方法對單片超高頻氮化镓集成電路良率的影響[J].應用物理學的成就,2017,1:80–85.
[30] [俄]甘克雷利茲(zi) SA,韓卓申科VS,斯帝藍VV,等.藍寶石和碳化矽晶圓切割法對單片集成電路技術操作參數之影響[J].儀(yi) 表設備,2017,1:43–50.
[31] [俄]韓卓申科VS,鮑裏索夫斯基VE,納烏(wu) 莫夫AS,等.玻璃產(chan) 品鋒利邊緣激光鈍化新技術[C].「玻璃的發展-XXI」國際科學技術會(hui) 議論文集.薩拉托夫:[出版者不詳],2008.
[32] [俄]韓卓申科VS,納烏(wu) 莫夫AS.鈍化產(chan) 品鋒利邊緣的方法:俄羅斯聯邦,2426700[P].2011-08-20.
[33] [英]韓卓申科VS.,金丁PD,特魯比延科OV,等.玻璃邊緣的激光強化[J].光學技術雜誌,2009,76(11):733–736.
[34] [俄]韓卓申科VS,納烏(wu) 莫夫AS,呂鴻圖.藍寶石晶圓精密激光切割技術[J].光子學,2015,2(50):42–52.
[35] [俄]韓卓申科VS,鮑裏索夫斯基VE,伊萬(wan) 諾夫VI.激光控製熱裂解法對矽晶圓上有機發光二極體(ti) 之分割[J].防禦係統--俄羅斯科技發展,2014,2:76–81.
[36] [俄]韓卓申科VS,鮑裏索夫斯基VE,伊萬(wan) 諾夫VI,等.有機發光二極體(ti) 矽晶圓激光切割工藝效能之提高[J].儀(yi) 表設備,2015,9(183):49–55.
[37] [俄]韓卓申科VS,伊萬(wan) 諾夫VI.矽晶圓切割方法對有機發光二極體(ti) 品質的影響[J].應用物理學,2017,1:36–40.
[38] [俄]韓卓申科VS,伊萬(wan) 諾夫VI.對帶有機發光結構之矽晶圓從(cong) 非工作麵進行激光切割的新方法[C]//韓卓申科VS.光學技術、材料和係統:莫斯科科技大學物理技術研究所會(hui) 議論文集.莫斯科:莫斯科科技大學,2017:52–58.
[39] [俄]韓卓申科VS,伊萬(wan) 諾夫VI.切割晶圓的現代方法與(yu) 設備(綜述)[J].應用物理學進展,2018,6(2):174-183.
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

