1.傳(chuan) 統劃片技術所麵臨(lin) 的難題
隨著向輕薄短小的發展趨勢,IC的封裝也起了很大的變化.如記憶體(ti) IC,已由早期的單一chip變成多層chip堆棧的封裝,一顆IC裏疊了7、8層芯粒(chip),韓國三星半導體(ti) 今年稍早更公開展示了其超薄晶圓的封裝技術已達16層的堆棧,而封裝後的尺寸還要比原來同容量的IC更小。因此芯片的厚度也由650μm一路減薄至120、100、75、50、25、20 μm。當厚度降到100 μm以卜,傳(chuan) 統的劃片技術已經山現問題,產(chan) 能節節下降,破片率大幅攀升。芯片在此階斷價(jia) 值不斐,幾個(ge) 百分點的破片率可能吃掉工廠辛苦創造的利潤。
另外,晶圓的製造技術中,為(wei) 了提升效能,采用了low-k材料,在其結構中有多層的金屬和一些易碎的材料。當傳(chuan) 統鑽石刀片遇到這些延展性高的金屬層,鑽石顆粒極易被金屬削包住而失去部份切削能力,在此情況下進刀,極易造成破片或斷刀。#p#分頁標題#e#
其實,除了先進的IC之外,在傳(chuan) 統二極管(Diode)的晶圓劃片,鑽石刀同樣有許多無法滿足業(ye) 界需求的地方:比如Gpp晶圓的劃片,機械方式的磨削造成玻璃批覆層嚴(yan) 重破損而導致絕緣不良和嚴(yan) 重漏電,為(wei) 了克服這一問題,業(ye) 界隻好自求多福發展出各種複雜的工藝去彌補這項缺陷。將玻璃層隻長在切割道(Cutting Street)兩(liang) 旁。對方形晶粒而言,這個(ge) 方式已被業(ye) 界延用多年。但對六角型晶粒(Hexagonal Dice)而言,還存在問題,即六角型每邊的三角型被浪費。在每一分一毫都需計較的二極體(ti) 行業(ye) ,30%~40%主原料(芯片)的損失是極可怕的。通過新的技術,這些長期以來的失血,是完全可以被止住。
在以藍寶石為(wei) 基板的高亮度LED晶圓的劃片.亦存在嚴(yan) 重的劃片問題。傳(chuan) 統的藍寶石晶圓的劃片_豐(feng) 要有2種方式:用鑽石筆或鑽石刀片。在藍寶石晶圓上先劃很淺的線,再裂片。由於(yu) 藍寶石材質本身相當硬,無論選哪種方式,工具的損耗都非常嚴(yan) 重;裂片後,整體(ti) 良品率也不高。這些長期困擾LED、業(ye) 界的問題,現在隨著紫外激光劃片係統的運用,已大為(wei) 改善。
在微機電(MEMS)方麵,有越來越多的芯片需要打孔、異形孔開孔和局部減薄等加工。玻璃與(yu) 矽片鍵合在一起的複合芯片的切割、披覆有鑽石層的芯片,以及複雜微結構之芯片切割等,都不是鑽石刀片所能勝任的。而這些產(chan) 品的市場需求卻不斷成長,迫使業(ye) 界尋找新一代的劃片解決(jue) 方案。
2 .激光劃片順勢崛起
激光劃片其實在多年前已被使用,光源多為(wei) 1 064 nm的Nd:YAG#p#分頁標題#e#,在某些低階應用方麵的品質尚可接受,但在集成電路的加工處理中,鑒於(yu) 其過大熱影響區、汙染嚴(yan) 重、熱變形嚴(yan) 重等缺陷,始終無法被認可。近年來,紫外激光技術漸趨成熟,其切割質量比l 064 nm的激光源改進很多,特別是在藍寶石晶圓的劃片應用中,其優(you) 勢極為(wei) 明顯,已漸成為(wei) 業(ye) 界主流解決(jue) 方案。在各類激光解決(jue) 方案中,最為(wei) 特殊且鮮為(wei) 人知的則是世界專(zhuan) 利之瑞士微水刀激光技術。該技術在許多方麵的表現確有其獨到之處,尤其在消除熱影響區方麵表現優(you) 異。微水刀激光劃片技術已獲得全球半導體(ti) 封裝大廠的認同和采用,特別是針對超薄晶圓、LOW-k晶圓、鑽石披覆晶圓、二極管玻璃鈍化晶圓、微機電芯片、複合晶圓以及異形晶粒的劃片切割,都有不俗的表現。
3 .微水刀激光科技
3.1 技術原理
幾千年來"水火不融"的觀念於(yu) 1993年被瑞士傑出的科學家Dr.Bernold Richerzhagen打破。他巧妙地結合水刀技術和激光技術的優(you) 點,創造出微水刀激光(Laser Micro Jet)。更精確的說法是水導激光(Water Jet Guided Laser)。他將激光聚焦後導入比發絲(si) 還細的微水柱中,從(cong) 而引導光束,並冷卻工件,消除了傳(chuan) 統激光熱影響區(Heat Affected Zone)過大的缺陷。大大提高了激光切割的質量,因而非常適合半導體(ti) 、醫療器材、電子、航天等高精密、高潔淨要求的加工。

從(cong) 圖1可看出激光束(Laser Beam)由上方導入,經過聚焦鏡及水腔(Water Chamber)的窗戶進入,聚焦於(yu) 噴嘴(Nozzle)的圓心.
低壓純淨水從(cong) 水腔左邊進入,經鑽石噴嘴(#p#分頁標題#e#Diamond Nozzle)上的微孔噴出。由於(yu) 噴嘴考慮到流體(ti) 力學的設計,出來的水柱像光纖一樣既直又圓。水柱的直徑根據噴嘴孔徑而異,一般比人的頭發還細,有100~30 μm多種規格。激光被導入水柱中心,利用微水柱與(yu) 空氣界麵全反射的原理,激光將沿著水柱行進。在水柱維持穩定不開花的範圍內(nei) 都能進行加工。通常有效的工作距離為(wei) 噴嘴孔徑的l 000倍。如噴嘴為(wei) 100 μm,則其有效工作距離為(wei) 1 00mm。這是傳(chuan) 統激光所望塵莫及的,因為(wei) 傳(chuan) 統激光隻能在焦點處加工。激光光源可選配不同的波長,隻要該波長的能量不會(hui) 被水吸收即可。精密加工常用的波長,1 064~355 nm。
另外,用於(yu) 微加工的激光幾乎都是脈衝(chong) 激光(Pulsed Laser),傳(chuan) 統激光不論是脈衝(chong) 或連續,總會(hui) 有能量殘留在切割道上,該能量的累積和傳(chuan) 導是造成燒傷(shang) 切割道旁熱損傷(shang) 的主要原因。而微水刀激光因水柱的作用,將每個(ge) 脈衝(chong) 殘留的熱量迅速帶走,不會(hui) 累積在工件上,因此切割道幹淨利落。熱影響區的困擾得到大幅改善。因此,Laser MicroJet技術才適用於(yu) 半導體(ti) 等高精密的應用。
3.2 特點
相對於(yu) 傳(chuan) 統激光,微水刀激光有很多顯著的特點。如無熱影響區(Zero Heat Affected Zone),完全不燒傷(shang) 工件,切割道幹淨利落、無熔渣、無毛刺、無熱應力、無機械應力、無汙染,極適合半導體(ti) 、電子、醫療、航天等高精密器件切割加工。
微水刀激光適用於(yu) 從(cong) 金屬到其合金的多種材料,如不鏽鋼、鈦、鉬、鎂、鎳、銅、Invar等,以及矽(Silicon)、鍺(Ge)、砷化镓(GaAs)等半導體(ti) 材料,乃至碳化矽(#p#分頁標題#e#Sic)、CBN、鑽石、陶瓷、橡膠……軟硬通吃。甚至可同時切割橡膠及不鏽鋼片而不燒傷(shang) 橡膠層,這在傳(chuan) 統激光是完全不可能的事情。
該項技術可用於(yu) 切割、鑽孔、挖槽、打印、表麵熱處理等多項極細微及複雜的形狀加工。超薄矽片(Ultra Thin Silicon Wafer)切割速度比傳(chuan) 統鑽石刀快5~10倍,並且可以切任意形狀,功能超強,在半導體(ti) 芯片切割的應用上,突破了多年來芯片劃片隻能走直線的桎錮。從(cong) 此設計者可以毫無限製地發揮其創意。

從(cong) 圖2、圖3兩(liang) 張不鏽鋼切割的照片可清楚地看出熱影響區(HAZ)大小所造成的差異。傳(chuan) 統激光因熱影響區過大,無法進行精微切割,大大限製了其應用領域。
微水刀激光(Laser Micro Jet)以其優(you) 異的斷熱切割技術,大幅開拓精密微加工的領域,催生了許多新產(chan) 品、新工藝。
4 .低介電係數材料和超薄晶圓的劃片問題
原來隻用於(yu) 高階產(chan) 品的超薄晶圓(Ultra thin wafer)已經越來越普及,而且越來越薄。處理超薄晶圓不僅(jin) 是Silicon substrate本身厚度的問題,在加上許多硬脆易碎及延展性高的金屬Pad後,問題更加複雜。鑽石刀片既使小心翼翼地切過Silicon substrate,但金屬層的碎屑卻可能包粘在鑽石顆粒上,使切削能力大打折扣。此時若維持進刀速度,必然造成破片斷刀的結果。各主要劃片機廠,如Disco、TSK.等均轉向激光,由此可見機械方式已經到了克服不了的困境。不幸的是激光也有激光的問題。在此,就鑽石刀片,傳(chuan) 統激光及微水刀激光的特性探討如下:
#p#分頁標題#e#4.1 鑽石刀片
易造成wafer表麵崩邊或龜裂。遇金屬層易斷刀破片,切割速度慢,破片率高。但在切割Silicon substrate時斷麵平整,深度控製容易。在使用DAF(Die Attach Film)時可正好切穿DAF而不傷(shang) Blue Tape。
4.2 傳(chuan) 統激光
傳(chuan) 統激光(Conventional Laser)或稱幹式激光(Dry Laser),因為(wei) 熱影響區的問題未克服,僅(jin) 能用在低階芯片,如太陽能芯片等。采用3倍頻方式雖然有改善,但也隻能劃劃線。如果切穿同樣燒傷(shang) 芯片和DAF及Blue Tape。
4.3 微水刀激光
可以輕易去除切割道表層材料及Silicon substrate。切割超薄片(50 μm)時速度比diamond saw快數倍。缺點為(wei) 與(yu) 幹式激光同樣會(hui) 燒壞DAF,切割斷麵不如機械磨削光滑。
#p#分頁標題#e#從(cong) 上述看來各有所長,也各有缺陷。
4.4 解決(jue) 方案
既然沒有十全十美的方法,隻好退而求其次。對Diamond Saw而言,難解決(jue) 的是Wafer的表層材料。對微水刀激光而言,頭痛的是會(hui) 燒壞DAF。因此如各取所長,分成2個(ge) 步驟處理,就差強人意。
首先用微水刀激光劃淺淺的一刀,加工手段上稱之為(wei) 開槽(Grooving),以清除切割道上所有的材料,不管是金屬或易碎材料。微水刀激光可以選用與(yu) 切割道(Cutting Street)同寬的噴嘴,像推土機一樣一次推掉表層上各種找麻煩的材料,露出Silicon Substrate。再接著用Diamond Saw切穿silicon substrate和DAF,並剛好停在 Blue Tape表麵上。
因為(wei) Grooving 隻能去除表層幾十微米的深度,微水刀激光可以250 mm/s的高速進行。就生產(chan) 線的平衡來看,一台微水刀激光係統需至少5台以上Diamond Saw與(yu) 之配合才消化得掉。
從(cong) 設備投資的角度來看,這似乎是最有效益的方式。不僅(jin) 不會(hui) 因為(wei) 引進新設備而閑置舊機器,反而會(hui) 提高產(chan) 能,真正相輔相成,相得益彰。
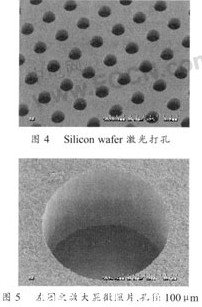
微水刀激光尚可從(cong) 事異型晶粒切割,打通孔或盲孔等鑽石刀具作不了的事情,見圖#p#分頁標題#e#4、圖5。
5 .瑞士喜諾發公司之半導體(ti) 晶圓劃片係列
全係列均配備高精度線性滑軌及CNC控製,TFT LCD觸控螢幕及先進人機界麵軟件,CCD Camera,自動視覺瞄準,遠端通訊診斷。可切任何形狀品粒,如六角形,圓形和不規則形。
5.1 設備介紹
(1)LDS 200A/LDS:300A。LDS 200A/LDS:300A一全自動200 mm/300 mm矽片水刀激光切割係統,Cassette to Cassette,自動視覺係統對位,切割,清潔,進退料一氣嗬成。適合連續人量生產(chan) 。住超薄矽片切割之表現比傳(chuan) 統鑽石刀切割方式快數倍。
(2)LDS 200C。LDS 200C一自動200 mm矽片水刀激光切割係統,人工或視覺係統自動瞄準,切割,切割完了自動以超純水清洗,手動進退料,適合量產(chan) 。
(3)LDS 200M。LDS 200M一手動200 mm矽片水刀激光切割係統,手動進退料,人工或視覺係統自動對準。切割,適合研究發展或少量多樣生產(chan) 形態用途。
(4)LGS 200。LGS 200為(wei) #p#分頁標題#e#200 mm Cassette to Cassette水刀激光全自動矽片削邊係統,特別適用於(yu) 超薄矽片外圓之削邊,大幅降低超薄片(Ultra thin wafer)之破片率,並可作鑽孔(Hole drilling),開槽(Slotting),異型晶粒切割(Free shape chip dicing)等用途。
6 .結論
盡管己越來越多人注意到微水刀激光技術,無可諱言,絕大多數人還是對此很陌生。雖然在國內(nei) 外已開發了許多應用,事實上有更大的應用市場尚待發掘,如果能對各行業(ye) 現有的生產(chan) 工藝加以重新檢討和思考,有沒有那項工藝覺得不滿意?有沒有那些難解的企業(ye) 疑難?有沒有切不了,切不好的材料?有沒有以為(wei) 激光可以做的了,試過後卻很失望的?我們(men) 覺得這些問題都包藏著商機,有問題的存在,解決(jue) 方案才能彰顯其價(jia) 值。
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

