ASML之後,再無來者?
在我們(men) 今天看來,晶體(ti) 管發明以後,集成電路的出現一直到今天超大規模集成電路的出現,似乎是一件水到渠成的事情。但是如果回到半導體(ti) 產(chan) 業(ye) 初興(xing) 的曆史現場,我們(men) 就會(hui) 發現沒有任何一項關(guan) 鍵技術的突破是“必然產(chan) 生”的。
(矽晶圓上的集成電路和電子元器件)
光刻技術,正是半導體(ti) 芯片得以出現的關(guan) 鍵技術之一,也仍然是今天芯片的核心製造工藝,光刻機更是被譽為(wei) 半導體(ti) 產(chan) 業(ye) 皇冠上的明珠。
在試圖探討我國如何實現半導體(ti) 產(chan) 業(ye) 突圍的當下,光刻技術和光刻機始終是我們(men) 無法回避的技術隱痛,也是我們(men) 必須跨越的技術高峰。
不過,高端光刻機所涉及的技術種類之多、技術難度之高、產(chan) 業(ye) 鏈之複雜,遠超外行人的想象。在半導體(ti) 產(chan) 業(ye) 七十多年的進程中,正是光刻技術的不斷改進推動了芯片結構的迭代升級,同時光刻技術以及相伴而生的光刻機、光源、光學元件、光刻膠等材料設備,也形成了極高的技術壁壘和錯綜複雜的產(chan) 業(ye) 版圖。
我們(men) 首先將回到光刻技術誕生的曆史現場進行還原,也會(hui) 深入到光刻技術的演進曆程,以及光刻機產(chan) 業(ye) 的競爭(zheng) 版圖中,讓我們(men) 獲得對於(yu) 光刻技術的全局視野,從(cong) 而也能更好理解當下我們(men) 所處的半導體(ti) 光刻機產(chan) 業(ye) 的競爭(zheng) 格局。
為矽晶體拍照,光刻技術的閃亮登場
從(cong) 晶體(ti) 管的發明到集成電路的出現,這中間還有一個(ge) 巨大的跨越,那就是如何將大量的電子器件微型化,以集成在一小片電路上。完成這一跨越,全世界最聰明的電子工程師們(men) 又花了十年時間,這十年也成為(wei) 電子技術史上麵的第一個(ge) 關(guan) 鍵時期。
20世紀50年代,在芯片出現之前,電子器件的連接幾乎都要依賴手工完成。當時美國海軍(jun) 的一艘航空母艦有35萬(wan) 個(ge) 電子設備,需要上千萬(wan) 個(ge) 焊接點。這樣的工程量使得電子設備的生產(chan) 效率嚴(yan) 重低下,電路的成品率也完全依賴操作人員的熟練度和準確度。
電子產(chan) 業(ye) 界都在呼喚微型化集成電路,也就是芯片的出現,而製作芯片的工藝正在貝爾實驗室中醞釀。
從(cong) 1950年起,貝爾實驗室的幾位化學家陸續完成了鍺晶體(ti) 和矽晶體(ti) 的提純。到1995年初,亨利·索羅製造出了雜質濃度小於(yu) 千分之一的矽晶體(ti) 。
與(yu) 此同時,化學家卡爾文·富勒領導的小組研發出高溫下鍺晶體(ti) 的雜質擴散工藝,可以通過精準地控製雜質進入鍺晶體(ti) 的深度和數量,製造出PN結。1955年,富勒研究小組已經把擴散技術應用在矽晶體(ti) 上麵,通過擴散技術將兩(liang) 種雜質注入矽片上,形成NPN結構。擴散技術至今仍然是晶體(ti) 管製造的基礎。
(貝爾實驗室以擴散技術製造的第一個(ge) 矽基晶體(ti) 三極管)
同時在貝爾實驗室工作的卡爾·弗洛希和林肯·德裏克為(wei) 擴散技術提出了一種全新的方式,那就是在矽片表明生成一層氧化膜,在其上蝕刻出窗口圖形,從(cong) 而使得雜質隻能從(cong) 窗口擴散到矽襯底中,而覆蓋氧化膜的地方則被保護了起來。
在這些基礎工藝實現之後,光刻技術的出現也呼之欲出。1955年,貝爾實驗室的朱爾斯·安德魯斯和沃爾特·邦德開始合作,將於(yu) 製造印刷電路的光刻技術用於(yu) 矽片加工。其方法就是在二氧化矽的氧化膜上均勻塗抹一層“光致抗蝕劑”(也就是光刻膠),隨即通過光學掩模的方式將窗口圖形暴露在這一圖層上,形成精準的窗口區域。然後再通過化學蝕刻將這一“窗口”形成,同時除去未曝光的“光致抗蝕劑”。最後再將所需雜質通過這些“窗口”擴散到下麵的矽襯底中,形成半導體(ti) 器件所需要的P型和N型結構,從(cong) 而構成更精準、更複雜的半導體(ti) 器件。
簡言之,光刻技術的實質就是將芯片所需要的電子線路和功能區製造出來。光刻機將光源通過掩模,對塗了光刻膠的矽晶圓進行曝光,曝光後的光刻膠發生變化,也就“複印”了掩模上麵的圖形,最終也就使得晶圓上麵產(chan) 生了電子線路圖。
純化技術、擴散技術、氧化層掩膜技術以及光刻技術,這些製造工藝技術填平了從(cong) 晶體(ti) 管分立器件到集成電子線路的巨大鴻溝。
不久之後,德州儀(yi) 器的基爾比和仙童半導體(ti) 的諾伊斯,就將這些來自貝爾實驗室的半導體(ti) 製造工藝應用在了集成電路的製造上麵,開啟了半導體(ti) 產(chan) 業(ye) 的騰飛之路。
光刻技術的“摩爾定律”升級賽
有趣的是,光刻技術的發展還有一條支線。就在貝爾實驗室取得半導體(ti) 技術進展的同時,當時為(wei) 美國國防部研究固態電路微型化的兩(liang) 位工程師傑伊.萊斯羅普和詹姆斯.納爾,早已在1952年開始使用光刻膠來製作鍺晶體(ti) 管。1957年,兩(liang) 人在貝爾實驗室研究成果的基礎上進一步推進了光刻技術,製成了小型化的晶體(ti) 管和陶瓷的混合電路,並創造了“光刻”(Photolithography)一詞。
(萊斯羅普和納爾申請的光刻專(zhuan) 利)
1958年,仙童半導體(ti) 的霍尼發明了平麵工藝,解決(jue) 了晶體(ti) 管的絕緣和連線問題,同時拉斯特和諾伊斯造出了世界上第一台光刻照相機,用於(yu) 矽基晶體(ti) 三極管的製造。1959年,仙童半導體(ti) 研製世界第一個(ge) 單結構矽晶片。1963年,研製出CMOS製造工藝,成為(wei) 今天IC產(chan) 業(ye) 的主流製造工藝。
六十年代初,光刻技術還非常初級,當時掩模板是一比一貼在晶圓上,而晶圓的大小也隻有1英寸。因為(wei) 原理並不複雜,就如同照相一樣,半導體(ti) 公司還能自己設計相關(guan) 光刻工具和裝備,但很快專(zhuan) 業(ye) 的光刻機出現,隨即成為(wei) 了芯片製造的關(guan) 鍵設備之一。
也就在1965年,英特爾創始人,時任仙童半導體(ti) 實驗室主任的戈登·摩爾通過觀察發現每代芯片幾乎都是前一代芯片容量的兩(liang) 倍,以此提出了推動半導體(ti) 技術持續升級的“摩爾定律”。當時的版本是,集成電路芯片上可容納的元器件數目,在價(jia) 格不變的基礎上每年翻一番。1975年,他又改為(wei) 每兩(liang) 年翻一番。
(摩爾定律的推進路線)
而摩爾定律實現的關(guan) 鍵正是光刻技術。隨著集成電路元器件尺寸不斷縮小,而芯片集成度和運算速度的不斷提高,對光刻技術的分辨率要求也越來越高。最終摩爾定律的實現正是同這一光學分辨率息息相關(guan) ,而光學分辨率則是由一個(ge) 瑞利公式決(jue) 定:
CD=K1*λ/NA
其中,CD為(wei) 曝光關(guan) 鍵尺寸,K1為(wei) 工藝常數,λ為(wei) 光波長,NA為(wei) 投影物鏡的光學數值孔徑。CD值越低,代表分辨率越高,也就是,光刻技術隻有每兩(liang) 年把CD降低30%~50%,摩爾定律才能得以應驗。
所以,提高光學分辨率的方法有三種,降低K1值,提高數值孔徑NA,降低波長λ。在現實的技術工藝中,K1值和NA值的改進有限,而降低曝光光源的波長λ成為(wei) 光刻技術持續推動的趨勢。
從(cong) 六十年代開始,半導體(ti) 曝光光源經曆了可見光、八十年代的436納米、365納米近紫外波段的高壓汞燈光源,再到九十年代的248納米深紫外波段的準分子KrF激光。一直到九十年代末的193納米ArF準分子激光,也就是今天主流電腦主機芯片製造還在使用的DUV激光光源。
正是193納米波長,成為(wei) 決(jue) 定今天光刻機產(chan) 業(ye) 格局的分水嶺。
麵對當時如何突破193納米波長的難題,科學界和光刻機產(chan) 業(ye) 界都在尋求超越它的方案。當時美國的SVG、日本的尼康,基於(yu) 前一代的幹式光刻法,選擇了看起來更穩妥的157納米的F2激光,美國能源部和英特爾發起,聯合摩托羅拉、AMD等組建了EUV LLC,主攻過於(yu) 超前的13.5納米的EUV極紫外光光源,此外還有更小眾(zhong) 的EPL、離子光刻等。不過當時這些嚐試都失敗了。
有趣的是,來自台積電的工程師林本堅,在2002年提出了一種基於(yu) 193納米波長,但改變幹式光刻為(wei) 浸潤式光刻工藝,也就是在光刻膠上方加上一層薄薄的水,來把193納米波長折射成134納米,一下子突破了157納米的難關(guan) 。此後浸潤式光刻技術經過多次的工藝改進,更是做到了22納米製程。
(ASML的第一台浸潤式光刻機)
而最早選擇浸潤式光刻技術的,就是那個(ge) “天選之子”一般的ASML。最終,在ASML和台積電的通力合作下,率先將193納米浸潤式光刻機生產(chan) 出來,也正是這一領先尼康三年的新產(chan) 品,讓ASML徹底贏得了光刻機絕大部分的市場份額。而潰敗的尼康再也沒能拿出更好的光刻機,而隻能停留在中低端市場當中。
在此之後,光刻機的高端賽道上隻剩下ASML和獨步天下的EUV光刻機。而這一段需要我們(men) 另辟專(zhuan) 題專(zhuan) 門去分析。
在光刻技術的數十年演進過程中,我們(men) 其實也能隱約看到一條光刻機產(chan) 業(ye) 的變遷路徑。
光刻機產業殘酷淘汰賽
毋庸置疑,半導體(ti) 晶體(ti) 管以及光刻技術的發端肇始於(yu) 貝爾實驗室。那麽(me) ,在專(zhuan) 利製度如此完善的美國,為(wei) 什麽(me) 貝爾實驗室及其背後的AT&T沒有成為(wei) 半導體(ti) 產(chan) 業(ye) 的領軍(jun) 者,而是在短時間內(nei) 有眾(zhong) 多的美國半導體(ti) 企業(ye) 迅速崛起?
這場技術革命之所以很快傳(chuan) 遍整個(ge) 產(chan) 業(ye) 界,源於(yu) 當時AT&T麵臨(lin) 反壟斷的壓力,不得不向美國政府表態,將半導體(ti) 技術公之於(yu) 眾(zhong) 。1956年,貝爾實驗室第三次召開半導體(ti) 晶體(ti) 管技術分享會(hui) ,正式公布了光刻、擴散技術和氧化層掩膜技術,連同早在1952年就出售的晶體(ti) 管生產(chan) 技術,直接壯大了德州儀(yi) 器、IBM、摩托羅拉、索尼等公司的半導體(ti) 技術,也間接催生了仙童、英特爾、AMD等後來的半導體(ti) 巨頭。
而光刻技術的公布和擴散更是引發了持續至今的光刻機產(chan) 業(ye) 的革新和版圖遷移。
最先受益的自然是美國企業(ye) 。1961年,美國GCA醫療技術公司造出了第一台光刻機。七十年代,美國Kasper儀(yi) 器公司、Perkin Elmer公司先後推出對齊式、投影式光刻產(chan) 品,占領了市場先機。1978年,GCA又推出了真正意義(yi) 上第一台自動化步進式光刻機Stepper,分辨率可以達到1微米,逐漸占據了市場主導地位。
(1980年,尼康推出步進式光刻機NSR-1010G)
由於(yu) 當時光刻技術門檻相對不高,六十年代末,日本的尼康和佳能因為(wei) 產(chan) 業(ye) 相近,也開始涉足光刻機產(chan) 業(ye) 。到了八十年代,尼康發售了自己首台商用步進式光刻機NSR-1010G,擁有更先進的光學係統和自研的鏡頭,開始從(cong) GCA手裏奪下了IBM、英特爾、AMD等一係列大客戶。
直到1984年,尼康已經可以和GCA平起平坐,各自占據30%的市場份額。Ultratech、Eaton、P&E、佳能、日立等剩下幾家瓜分剩下的40%。
(圖中的簡易木板房就是ASML最初的辦公地點)
而這一年,未來光刻機產(chan) 業(ye) 的霸主ASML(先進半導體(ti) 材料光刻公司),在荷蘭(lan) 飛利浦公司和一家名叫ASMI的小公司合作下成立。成立之初,ASML隻有31名員工,並且隻能在飛利浦大樓外的簡易木房裏辦公。ASML的崛起還有一段時間,八十年代是日本半導體(ti) 和光刻機產(chan) 業(ye) 的“光輝歲月”。
隨著1986年半導體(ti) 市場大滑坡,GAC的新產(chan) 品開發停滯,隨即被收購,再之後因無人接手而關(guan) 門。Ultratech 在被管理層收購後停滯不前,P&E的光刻機部門也在1990年被賣給了SVG。八十年代末,美國的光刻機三巨頭隕落,而日本的尼康、佳能占據了絕大部分市場份額,剛剛起步的ASML也隻拿到10%的市場份額。
而到了90年代,就是尼康和ASML雙雄競爭(zheng) 的時代,不過因為(wei) 世紀之初的那一場技術路線之爭(zheng) ,尼康落敗,ASML一騎絕塵,一直到今天其光刻機產(chan) 業(ye) 霸主的地位仍然牢不可破。
總體(ti) 來看,在光刻技術發展的六十年時間裏,光刻機企業(ye) 走馬燈似的快速淘汰和轉移,其實背後有一個(ge) 非常現實的矛盾。就是光刻機作為(wei) 芯片製造的上遊產(chan) 業(ye) ,銷售市場非常狹窄,銷量也十分有限,當時一家的年銷量也不過幾十台,但是光刻機又是一個(ge) 需要巨額資金持續投入研發、持續更新迭代的高精尖技術,而且隨著芯片製程越小,技術難度又呈現指數級增加。
因此,一旦一家企業(ye) 出現產(chan) 品的技術停滯或斷檔,領先一步的企業(ye) 就會(hui) 拿走少數幾家半導體(ti) 廠商的絕大多數訂單,而落後的企業(ye) 也因失去關(guan) 鍵營收而無力進行光刻機新品的研發和生產(chan) ,也就失去贏得競爭(zheng) 的機會(hui) 。
簡單來說,光刻機產(chan) 業(ye) 的邏輯就是贏者通吃,尼康的敗局就是前車之鑒。
我國光刻機產業現狀與可能
回到我國的半導體(ti) 產(chan) 業(ye) 突圍的問題上來,最核心的一項任務就是實現高端光刻機,特別是EUV光刻機的國產(chan) 化。
不過,當我們(men) 了解了光刻技術的演變和光刻機產(chan) 業(ye) 遷移過程之後,可能會(hui) 更冷靜地麵對當前無比艱難的競爭(zheng) 格局。
首先,我國在入局光刻機產(chan) 業(ye) 的時間並不短,但是我們(men) 在核心技術和專(zhuan) 利上的積累仍然嚴(yan) 重不足。專(zhuan) 利技術受製於(yu) 人成為(wei) 卡住我國半導體(ti) 產(chan) 業(ye) 咽喉的巨大隱痛。
(全球光刻機專(zhuan) 利主要申請的公司)
一直以來,日本的尼康、東(dong) 京電子、佳能都是光刻機專(zhuan) 利的申請大戶。90年代之後,ASML的光刻機專(zhuan) 利數也大幅增加,並且在日本也布局了大量專(zhuan) 利。此外在中國台灣、美國和韓國也有較多的專(zhuan) 利布局。相比之下,我國的光刻機相關(guan) 專(zhuan) 利申請比例仍然很低,且近幾年也並未有增加的趨勢。基礎技術壟斷、技術研發門檻高,可能成為(wei) 我國光刻機行業(ye) 難以突破的一大因素。
(芯片中場效應管的架構發展)
其次,就在我們(men) 意識到要推動半導體(ti) 產(chan) 業(ye) 自主化的時候,芯片製造的摩爾定律已經在逼近極限,其中一大限製因素正是光刻工藝製程已經接近理論極限。當芯片製程工藝向5納米以下演進時,如何打破物理的、材料的極限,成為(wei) 擺在光刻機和半導體(ti) 製造企業(ye) 麵前的現實難題。
另外,為(wei) 應對日益高昂的芯片製造成本,芯片行業(ye) 采取的方式就是企業(ye) 間的並購重組,到目前最先進的芯片生產(chan) 線隻屬於(yu) 英特爾、台積電、三星和格羅方德等少數幾家芯片製造巨頭,他們(men) 與(yu) 原材料和像ASML等設備商構成一個(ge) “你中有我,我中有你”的壟斷格局。
對於(yu) 我們(men) 國內(nei) 的光刻機產(chan) 業(ye) 來說,既麵臨(lin) 壁壘森嚴(yan) 的技術專(zhuan) 利封鎖,又直接遭遇接近技術演進極限的產(chan) 業(ye) 階段,還要麵對處於(yu) 完全壟斷地位的ASML的壓倒性優(you) 勢,我們(men) 此時發起的技術挑戰,真的注定是一場無比艱難的極限挑戰。
對於(yu) 關(guan) 心半導體(ti) 產(chan) 業(ye) 突圍的大眾(zhong) 而言,恐怕更加不能心急,期望我國的光刻機技術在短短幾年內(nei) 就能追趕甚至超過國外巨頭。我們(men) 更應該冷靜地認清一個(ge) 現實,光刻機作為(wei) 芯片製造中最精密、最複雜、難度最大、價(jia) 格最昂貴的設備,早已不再是一個(ge) 國家或者少數幾家企業(ye) 可以完成的工程了。
想要研製出最先進的光刻機設備,必須與(yu) 全球頂級的光源、光學、材料以及關(guan) 鍵零部件等廠商進行合作。即使在美國試圖封禁我國半導體(ti) 產(chan) 業(ye) 發展的艱難環境下,我們(men) 也不能放棄與(yu) 國外這些先進技術企業(ye) 交流、合作的機會(hui) 。
(武漢光電國家研究中心研製的“9納米光刻機”)
當然,除了依靠商業(ye) 合作之外,更重要的是我國的半導體(ti) 企業(ye) 要努力實現在某些技術領域的技術突破,隻有在掌握“人無我有”的前端技術的情況下,我們(men) 才有足夠的話語權來與(yu) 這些高手過招,也才有可能加入到高端光刻機製造的產(chan) 業(ye) 分工當中。
當然,令人欣喜的一方麵是,我國對光刻機技術的自主化有了真正的意識和推動,我國的光刻機產(chan) 業(ye) 正在實現技術突破。後麵我們(men) 將對此有更加詳盡的探討。
參考文獻:
1.《芯片改變世界》,“芯片工藝:貝爾實驗室奠定的半導體(ti) 工藝基礎”,2019年10月。
2.《科學》,“光刻技術的曆史與(yu) 現狀”,2017年第三期。
轉載請注明出處。






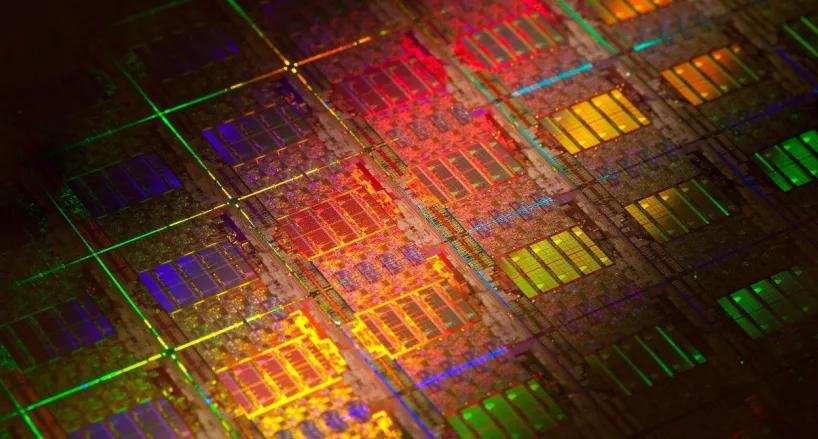







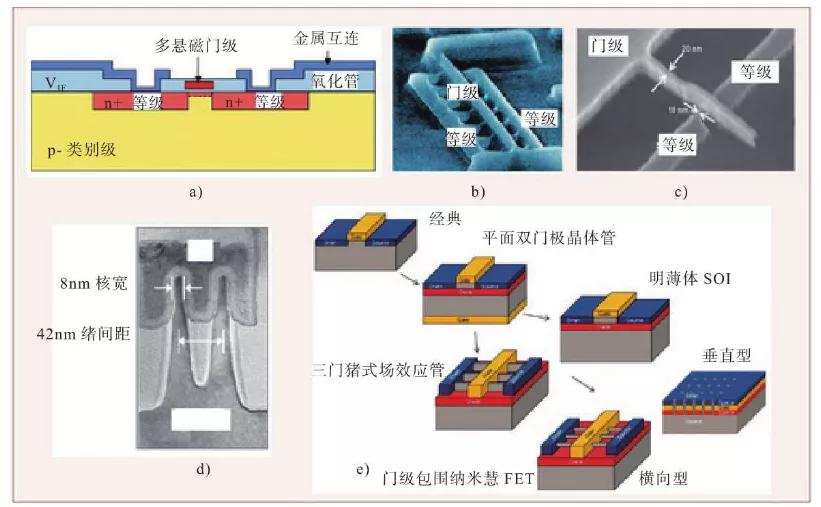
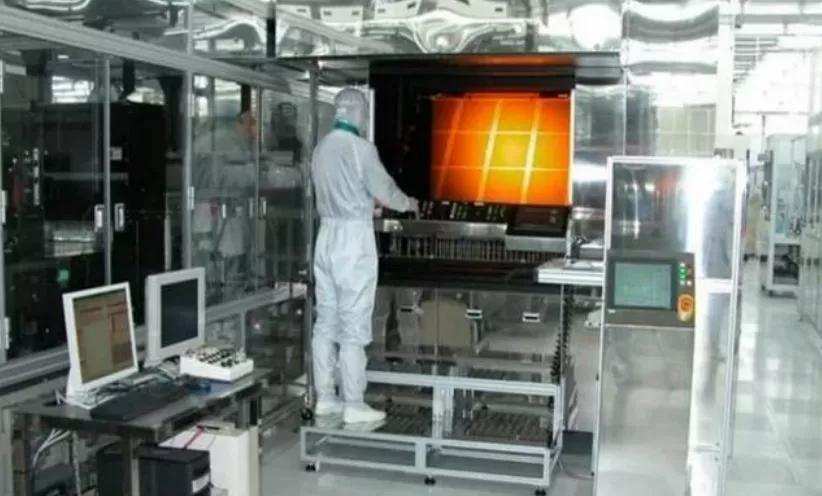

 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

