極紫外光刻(EUVL)技術已經醞釀了超過四分之一個(ge) 世紀,去年第一台EUVL生產(chan) 工具已經交付客戶,芯片製造商和供應商正在試生產(chan) 線上日趨完善這項技術以備日後的大規模批量生產(chan) (HVM)。雖然許多技術和商業(ye) 領域取得的卓越進展為(wei) EUVL進行大規模批量生產(chan) 做好了準備,但是整個(ge) 產(chan) 業(ye) 可以使EUVL進入真正的HVM階段還需要解決(jue) 一些關(guan) 鍵的技術和行業(ye) 挑戰。
EUVL技術已經醞釀了超過四分之一個(ge) 世紀,開拓性的工作發生在20世紀80年代的中後期,並在20世紀90年代致力於(yu) 研發工作,最終出現了大批產(chan) 業(ye) /國家實驗室合作開發(EUV LLC/VNL 項目),首先驗證了所有的技術要素,數值孔徑為(wei) 0.1的全視場樣機工具。美國半導體(ti) 製造技術產(chan) 業(ye) 聯盟(SEMATECH)在20世紀90年代晚期開始EUV項目幫助實現EUVL基礎設施。頭幾年SEMATECH的EUVL基礎設施開發重點包括光學元件、光源、EUV抗蝕劑和EUV掩模開發。一旦光學元件和光源於(yu) 21世紀早期得到了足夠的產(chan) 業(ye) 動力,SEMATECH 開始通過SEMATECH 抗蝕劑開發中心(RMDC)和SEMATECH 掩模基板開發中心(MBDC)全力開發EUV 抗蝕劑和掩模。到本世紀第一個(ge) 十年的中期,商業(ye) 供應商已經建立了全視場EUVL阿爾法工具,在2010 年開始向客戶交付測試曝光工具,2013年交付首台產(chan) 品工具。在21世紀初,EUVL的最初目標是利用100nm,隨後產(chan) 生的問題是:我們(men) 現在終於(yu) 越來越接近將EUVL引向大規模製造了嗎?
整個(ge) 行業(ye) 快速接近了國際半導體(ti) 路線圖(ITRS)為(wei) MPU和DRAM概述的22nm半間距節點。由於(yu) EUVL目前不能滿足生產(chan) 要求,領先的設備製造商決(jue) 定利用多圖形193nm沉浸式光刻。然而,如果EUVL在不久的將來滿足了生產(chan) 量和生產(chan) 率的要求,公司就會(hui) 借機通過在22nm半間距的選擇層內(nei) 插入EUV實現成本節約,而不選擇更加昂貴的MP193i。一旦EUV光源滿足了生產(chan) 要求,還有待觀察具體(ti) 的技術挑戰,如光源組件壽命或有益掩模壽命是否會(hui) 隨光源功率而擴大。截至今日,EUV 重點仍然是滿足生產(chan) 要求的同時,掩模產(chan) 量、缺陷檢查/審查基礎設施,以及保持使用過程無掩模缺陷,包括EUV防護解決(jue) 方案,仍然是明確的第二優(you) 先級。
EUV光源現狀
EUV光源仍然是行業(ye) 麵臨(lin) 的最困難的技術挑戰。目前還沒有哪家公司能夠為(wei) 光源的可靠性和正常運行時間提供足夠高的光源功率和成熟的光源技術,即不能為(wei) EUV在大規模生產(chan) 製造提供可靠穩定的光源。業(ye) 界的目標是支持22nm節點的EUV HVM,在2014年中間焦點(IF)提供125W輸出,2015年提供250W輸出。為(wei) 了實現這一目標,用於(yu) 產(chan) 生EUV輻射的CO2激光器的功率就要在測試版的15kW的基礎上翻兩(liang) 倍,1064nm波長CO2到13.5nmEUV波長的轉換效率至少提高一倍達到~3%。而CO2激光驅動功率大於(yu) 35kW的隻有一個(ge) 光源供應商,並且需要現場複製。用於(yu) 調節錫靶的預脈衝(chong) 技術對於(yu) 優(you) 化轉換效率是很重要的,預脈衝(chong) 將錫液滴優(you) 化到目標形狀填充泵浦激光器的聚焦光束束腰;預脈衝(chong) 的波長可以與(yu) 主脈衝(chong) 的波長相同。根據不同的設置,預測最大的轉換效率可以達到6%。迄今報道的預脈衝(chong) 係統的最高功率值是50W,最近報道的持續6分鍾的最高功率達到70W。
除了滿足原始光源功率的目標,光源還需要滿足HVM的可靠性和可用性要求。這就需要可以確保光學部件(如收集器、穩定CO2激光器聚焦控製和錫液滴穩定型)長壽命工作的碎片緩解係統。然而在期望的EUV光源功率水平上還沒有足夠的可利用現場數據來評估EUV光源的可靠性和可利用性將會(hui) 麵臨(lin) 多大的技術挑戰,然而,已經表明導入背景氣體(ti) 消除收集器上生長的錫可以使連續激光脈衝(chong) 生成的衝(chong) 擊波扭曲輸入錫液滴導致能量不穩定的液滴軌跡;這個(ge) 問題也會(hui) 隨著激光功率的增加變得更糟,而在同一時間需要更高的背景氣體(ti) 壓力來減輕錫在收集器上的生長。
必須克服高功率EUV光源麵臨(lin) 的挑戰是很好理解的,而且目前投入了大量的資金來解決(jue) 這些問題。然而,誰也不能保證這些目標就一定能實現或達到這些預期。過去十年的EUV光源功率預測和技術路線圖就證明了我們(men) 行業(ye) 對於(yu) 預測EUV光源性能發展是很離譜的。如果EUV HVM引入沒有發生在16nm節點,目前的工具數值孔徑0.33將不能提供足夠高的k1值,適用單圖層及以下節點。然而,無論是EUV雙層圖案還是高NA值EUV都要求較高光源功率(EUV雙層圖案比高NA值EUV稍低一點),因此,從(cong) EUV光源角度來看,節點尺寸大於(yu) 16nm半間距的HVM導入情況可能變得更糟。為(wei) 了降低這種風險,業(ye) 界應當推行兩(liang) 種做法:a)對於(yu) <1kW的光源,盡量采用驅動電流電源技術,努力使它支持16/11nm節點半間距的EUV;b)對於(yu) >1kW的光源,執行應急方案,利用現有的知識/能力建立一個(ge) 自由電子激光器(FEL)樣機。與(yu) 此同時,我們(men) 必須開拓新的自由電子激光器的概念和技術,拓展這種技術規模使其更加實用。
展望
當考慮引入EUVL技術的情況下,我們(men) 需要考慮產(chan) 品的具體(ti) 要求來了解目前關(guan) 鍵參數的狀態,如電源功率和掩模基板缺陷。下圖突出了行業(ye) 的當前狀況,並顯示了開始使用EUVL的光源功率和掩模基板缺陷水平。圖1是一個(ge) 簡化示意圖,但它表達了一個(ge) 重要信息,邏輯製造商以及他們(men) 的代工企業(ye) 是最有可能率先啟動EUVL的。在邏輯製造商之間,代工企業(ye) 在他們(men) 目前的商業(ye) 模式擴展多個(ge) 圖案是很困難的,因為(wei) 他們(men) 必須遷就所有客戶的設計空間,而一個(ge) 獨立的設備製造商可以控製設計、技術和製造一係列過程,比代工廠可以進一步推動特定技術。
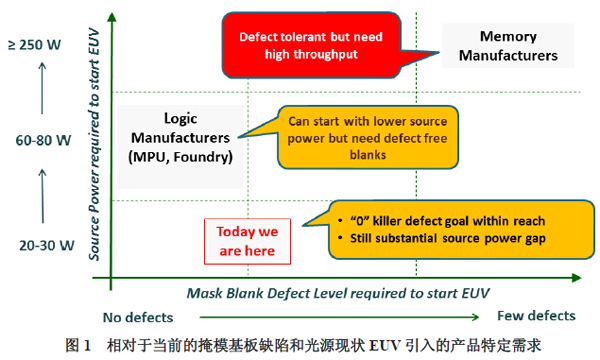
所有上述引發了一個(ge) 問題:EUV到底要延遲多久?答案很簡單:不再延遲了。EUV最初是針對更大節點(21世紀初的70nm 特征尺寸),現在是接近錯失的10nm節點。如果錯過了10nm節點,那麽(me) 隻剩下一個(ge) 節點,目前的一代工具可以支撐使用單圖案:隨著目前0.33NA一代工具引入EUVL,7nm節點是最後的單圖案節點。對於(yu) 更小的節點,人們(men) 必須考慮雙重圖案或者在采用雙圖案之前轉移到更高NA的一代極紫外光刻工具保持單圖案在兩(liang) 個(ge) 節點上。
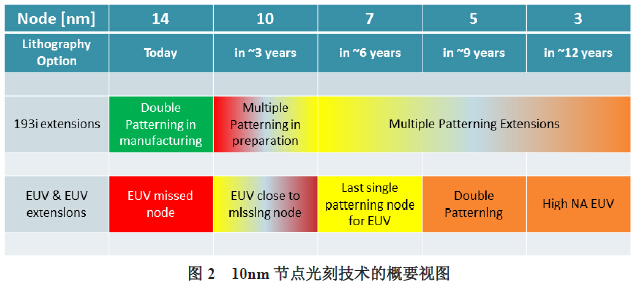
盡早引入EUVL的推動因素是多圖案的高成本和複雜性。多圖案已經成為(wei) 10nm節點的一個(ge) 現實,大部分公司都可能在7nm節點采用多圖案方案,即使外觀看起來不美觀。將多重圖案在10nm或7nm節點的假設成本與(yu) 今天EUVL 技術的預計成本相比較會(hui) 遺漏一個(ge) 重要的、有助於(yu) 降低多重圖案成本的參數,即工程師的聰明才智會(hui) 不斷改善方案,利用工具推動圖案成本降低,如定向自組裝(DSA)。因此,EUV技術需要把目標定在10nm節點生產(chan) 上,盡快從(cong) 相同的製造優(you) 先選項獲取利益,通過整個(ge) 製造產(chan) 業(ye) 鏈來推動成本降低。如果EUVL沒有在10nm節點被領先優(you) 勢的製造商引入,EUVL將麵臨(lin) 在7nm節點引入的非常高的障礙。
EUVL降低了設計和工藝複雜程度,EUV HVM工具產(chan) 生的第一幅印刷圖像展示了預期圖像質量,然而業(ye) 內(nei) 人士正在等待,看看客戶端的第一生產(chan) 工具的可靠性數據和產(chan) 量提高是否能達到預期。雖然在關(guan) 鍵的掩模基礎設施挑戰上,如掩模基板無缺陷,取得了重要進展,設施的其他部分的挑戰仍然存在,如商用EUV防護解決(jue) 方案,包括一個(ge) 兼容的EUV掩模工具設備不會(hui) 使用很多年。如今引入EUV製造主要是受到持續生產(chan) 力挑戰的阻礙。關(guan) 鍵的是這些生產(chan) 率的挑戰很快就會(hui) 解決(jue) ,芯片製造者可以開始製造學習(xi) 10nm節點並且在7nm節點插入技術。雖然目前EUVL被認為(wei) 是能夠滿足半導體(ti) 產(chan) 業(ye) 需求、顯著降低成本的唯一技術,但是如果在降低雙重圖案成本或者針對特定產(chan) 品的競爭(zheng) 技術成為(wei) 可能的情況下,上述圖表或許會(hui) 發生變化。#p#分頁標題#e#
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

