激光直寫(xie) 光刻技術是一種利用曝光強度可控的激光束來光刻曝光,並在顯影後得到具有期望形貌微結構的3D光刻技術。
該技術可以通過計算機對激光的曝光位置與(yu) 曝光強度進行數字化控製,實現對光刻膠的變劑量曝光,因此具有很高的製造靈活性。
下圖為(wei) 激光直寫(xie) 光刻設備的工作原理示意圖。

激光器出射激光,經由光學係統對光束的光強和通光量進行調控。最後,物鏡將光斑匯聚到光刻膠上表麵。
計算機同時對激光器的出射激光功率以及二維移動平台的運動進行控製,從(cong) 而控製激光束的曝光能量和位置。最後,對經過數字化曝光的光刻膠顯影,即可得到具有期望形貌的3D微結構。

激光直寫(xie) 光刻技術並不是單一獨立的技術,它是包括了以激光直寫(xie) 光刻技術為(wei) 核心的一套工藝技術。
這些技術具體(ti) 包括有襯底表麵處理技術、光刻膠旋塗技術、光刻膠前烘技術、激光直寫(xie) 光刻曝光技術、顯影以及後烘(PBE)技術。具體(ti) 的流程如下圖所示。
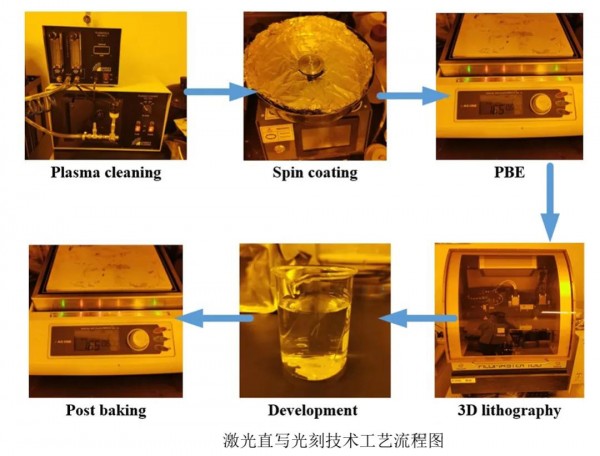
一、表麵處理
表麵處理技術是激光直寫(xie) 光刻技術流程中的第一道工藝。
它主要目的是有效的清潔襯底的表麵,從(cong) 而使襯底的表麵不具有灰塵。如果襯底的表麵具有灰塵,旋塗後的光刻膠會(hui) 因為(wei) 灰塵顆粒而不均勻的分布在襯底表麵,進而影響到後續的光刻工藝。
目前,常見的襯底有玻璃襯底與(yu) 矽襯底。由於(yu) 拋光後的矽片表麵比較光滑,因此不需要表麵處理,隻需要用氮氣吹走其表麵的顆粒即可。
較為(wei) 常用的襯底為(wei) 玻璃襯底。玻璃襯底表麵較為(wei) 粗糙,易於(yu) 吸附灰塵,因此需要用酒精對表麵進行清洗。
二、塗光刻膠
在對表麵處理後,需要對光刻膠進行塗布。光刻膠的塗布方式有旋塗,噴塗以及浸塗3種方式。
其中,旋塗是常見的抗蝕劑塗層技術。該種方式塗抹後的光刻膠表麵非常光滑和均勻。先將光刻膠滴塗到清理後的玻璃襯底上,然後再用勻膠機對光刻膠進行旋塗。一般光刻膠塗抹厚度與(yu) 自旋速度的平方根的倒數成正比。
同時,光刻膠的種類也會(hui) 對光刻膠的膠厚有影響,而光刻膠的厚度會(hui) 決(jue) 定可製備微結構的最大高度。有時為(wei) 了增加塗布厚度,會(hui) 使用Plasma清洗機對玻璃襯底的表麵進行親(qin) 水處理:氣體(ti) 為(wei) O2;時間為(wei) 30s;功率為(wei) 100W。
三、前烘
在完成對光刻膠的旋塗後,接下來需要對光刻膠進行前烘。在製備厚膠微結構時,即製備高度大於(yu) 20μm的微結構,需要對前烘的時間與(yu) 前烘溫度進行一定的改善。光刻膠的厚度越厚,前烘的時間越長。時間甚至可長達5min以上。
薄膠微結構不需要考慮光刻膠中的N2逃逸問題,因此烘烤的主要目的是將光刻膠變得堅固。而對厚膠微結構,光刻膠中會(hui) 產(chan) 生N2氣泡。為(wei) 此,在烘烤過程中緩慢升溫,以實現對N2氣泡的驅趕。
四、曝光
對光刻膠烘烤後,需要將光刻膠放置在激光直寫(xie) 光刻設備中,以實現光刻膠的曝光。

激光直寫(xie) 光刻設備的曝光參數主要有曝光光斑尺寸、曝光劑量、激光光斑移動步長、離焦補償(chang) 量。光斑中的光斑尺寸以及對應焦深是決(jue) 定可製備結構尺寸的兩(liang) 個(ge) 重要的參數。
當光斑較小時,光斑適合製備具有較小特征尺寸的3D結構。但是當光斑較小時,數值孔徑較小,因此很難製備較高的結構。
相反,當光斑較大時,光斑不適合製備具有較小特征尺寸的3D結構。但是光斑較大時,數值孔徑較大,焦深夠大,因此適合製備較高的結構。
通常,當製備較大結構時,一般使用500nm光斑。激光光斑移動步長為(wei) 激光光斑尺寸的一半。通過這種光斑的疊加,可以製備具有更高高度和低粗糙度的高深寬比微結構。曝光劑量需要根據製備微結構的高度決(jue) 定。焦點補償(chang) 需要由光刻膠厚度決(jue) 定。
五、光刻膠選擇
光刻膠的種類多種多樣,按照感光光源其種類可以分為(wei) 紫外(300~450nm)光刻膠、深紫外(160~280nm)光刻膠以及極紫外光刻膠(曝光波長僅(jin) 幾十納米)等。
隨著光刻結構特征尺寸越來越小,化學放大膠逐步成為(wei) 集成電路產(chan) 業(ye) 中常用的光刻膠。按照激光曝光後光刻膠內(nei) 化學成分的反應,光刻膠也分為(wei) 光刻正膠與(yu) 光刻負膠。
一般激光直寫(xie) 光刻技術的常用膠為(wei) 光刻正膠。另一種3D光刻技術,雙光子光刻技術,一般運用光刻負膠對微納結構進行製備。
針對光刻膠的成分而言,盡管不同的光刻膠具有不同組分,但是目前主流光刻膠主要由感光劑、成膜樹脂、溶劑以及少量添加劑構成。成膜樹脂作為(wei) 成膜載體(ti) ,具有很好的堿溶性。而光敏化合物的作用是對在堿性環境中的成膜樹脂溶解進行抑製。當它們(men) 混合在一起時,組成的六元化合物不溶於(yu) 堿性溶液。然而,當光敏化合物被激光輻照後,它會(hui) 發生分解。光敏化合物分解後的產(chan) 物反而會(hui) 促進堿性環境中的成膜樹脂的溶解。在被輻照前,光刻膠屬於(yu) 大分子材料。當其被輻照後,大分子材料裂解成小分子材料。顯影後,可能有部分小分子材料填充光刻膠圖案的表麵,從(cong) 而減少了結構的粗糙度。
然而,隨著激光直寫(xie) 光刻技術的興(xing) 起,紫外(300~450nm)光刻正膠又重新走進了激光直寫(xie) 光刻行業(ye) 內(nei) 相關(guan) 從(cong) 業(ye) 人員的視野中。
根據光刻膠對激光的吸收效率,紫外(300~450nm)光刻膠進一步劃分為(wei) G線(436nm)光刻膠以及I線(356nm)光刻膠。
六、顯影
當光刻膠被激光直寫(xie) 光刻設備曝光後,需要對其顯影,以得到期望的微結構。AZ400K是一個(ge) 較為(wei) 常用的顯影液,其主要成分是KOH。為(wei) 了防止顯影速度過快,倒入超純水以稀釋顯影液。
在顯影的過程中,當製備的結構較高時,有一些光刻膠會(hui) 困在微結構之間。這些困在微結構之間的光刻膠會(hui) 阻止顯影液與(yu) 其下層的光刻膠反應。
最後,需要將顯影後的光刻膠微結構放置在熱板上進行後烘。這一步是為(wei) 了將光刻膠中的水分烘烤出來,並使光刻膠中的化學物質充分反應。一般後烘的溫度低於(yu) 光刻膠的熔點。
在顯影後,初步得到光刻後微器件結構,在後續的刻蝕與(yu) 氧化後形成器件。
參考文獻:
(1)黃軼 飛秒激光直寫(xie) 微光學器件及其光學特性研究[D].
(2)欒世奕 基於(yu) 3D光刻技術的多功能微透鏡陣列製造及研究[D].
(3)陳力 基於(yu) 激光誘導法的玻璃通孔製備技術及無源器件集成研究[D].
轉載請注明出處。







 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀



















 關注我們
關注我們

